出品机构:甲子光年智库
研究指导:宋涛
研究团队:韩义
发布时间:2022.12
�
甲子光年智库报告产品体系
甲子光年智库报告产品共分为四个类级,第一类为微报告,聚焦一个问题,风格简洁明要
图:甲子光年智库四级报告产品体系
甲子光年智库微报告产品介绍
1
微报告
• 研究风格简洁明快
• 一个报告只解决一个关键问题,并
提出一个核心观点
深度报告
2
• 以洞察趋势、实践研究为主
• 具备核心观点、核心数据和典型案
例
定制
报告
3
• 根据客户的定制化需求开展深度行
业研究
• 以深度研究、定义赛道为主
4
咨询
报告
• 提供深度问题解决的咨询服务为主
• 聚焦发现问题、分析问题、解决问
题
数字化概念层出不穷,细分赛道迭代速度加快,相关从业
人员需要新鲜、专业的市场分析及洞察。
因此,甲子光年智库推出科技行业系列“微报告”,向市
场分享最新的细分行业洞察。
报告特点:
I.
II.
简洁明快:内容较短,方便快速阅读与碎片化阅读;
直击重点:聚焦一个关键问题进行展开分析;
III.
分享观点:拒绝平铺直叙,亮出智库独有观点;
后续,针对半导体先进封装行业的深度分析,敬请关注甲
子光年智库的《半导体先进封装行业研究报告》深度报告
�
目 录
Part 01 半导体先进封装发展背景
Part 02 半导体先进封装定义
Part 03 半导体先进封装市场结构及规模
Part 04 半导体先进封装产业链图谱
Part 05 半导体先进封装产业竞争格局
Part 06 案例征集
�
Part 01 半导体先进封装发展背景
新材料、新工艺和新技术支撑集成电路产业一直延续摩尔定律发展,但受复杂工艺、
技术瓶颈等因素影响,摩尔定律正逼近物理、技术和成本的极限
摩尔定律依然有效,但逐渐放缓
芯片制造成本持续增加
250mm² 芯片每mm²产出成本
6
5
4
3
2
1
0
45nm 32nm 28nm 20nm 14/16nm 7nm
5nm
�
Part 01 半导体先进封装发展背景
后摩尔时代产业发展路径,延续摩尔?超越摩尔?
在后摩尔时代,芯片发展逐渐演化出了不同的技术方向。其中,“延续摩尔”方向,延续CMOS的整体思路,其本质是通过采用新的器件的结构
和布局来实现芯片的设计和加工,沿着摩尔定律的道路继续向前推进,不断缩小芯片制程。“超越摩尔”方向,主要是发展之前摩尔定律演进过
程中未开拓的技术方向。先进封装便是超越摩尔技术方向的一种重要实现路径。
制程微缩,在材料、工艺等方面进
行创新研发,沿着摩尔定律发展
侧重功能多样化,在系统集成方式上
创新,不执着于晶体管的制程缩小
More Moore
More than Moore
CMOS以外的新器件
提升集成电路性能
Beyond CMOS
电路设计以及系统算法优化
芯片高性能+新功能
通过封装技术来实现集成
为了实现在一个系统中更有效的整合、应用各种不同的芯片和传感器,半导体大厂及封装厂商都开发出了许多类型先进封装技术
�
Part 01 半导体先进封装发展背景
延续摩尔路径下,先进制程发展受到外部牵制,超越摩尔路径下的先进封装或成为突围点
美国《芯片与科学法》有针对性地提出:“禁止接受资金补助企业在对美国构成国家安全威胁的国家建造/扩大先进制程晶圆厂,并且禁止接受法
案资助的公司在中国和其他特别关切国家的扩建某些关键芯片制造。”
2022年10月7日:美国商务部工业与安全局宣布修订出口管理条例,补充和修改了三项共计9类出口管制新规。其目的是进一步限制中国购买和
制造某些特定用途的高端芯片的能力,限制中国获得先进计算芯片、开发和维护超级计算机以及制造先进半导体的能力;
问题与现象
2022年中国进口集成电路金额
需求端降温:缺芯问题缓解,消费电子疲软
贸易摩擦:美国数次通过贸易保护政策和单边制裁方案,
限制我国芯片产业发展
Jan
Feb Mar
Apr May
Jun
Jul
Aug
Sep Oct Nov
-19.5%
�
Part 01 半导体先进封装发展背景
同时,下游产品向集成化和小型化发展、带来对于高密度、低功耗的封装技术要求,促使
先进封装不断发展
集
成
化
小
型
化
新能源的功率模块
功率器件持续面临着增加功率密度及可靠性的需求。小型化、功
能系统化、模块化封装成为了当前功率半导体封装技术发展的主
要方向
AI和高性能计算
AI为代表的应用对高性能、低功耗大带宽需求的增加,先进封装
是实现高带宽、高速数据交换的重要技术途径
可穿戴设备
智能电子产品将逐渐突破系统小型化和微型化设计局限,伴随先
进封装技术发展,实现将几百个器件封装在极其微缩的产品中
医疗技术
更小、更智能、超微创的器械
物联网的传感器
……
需要做到低成本、散热良好以及在封装内可支持多种标准的射频
屏蔽。同时对于部分IoT应用有大小与高度限制
�
Part 02 半导体先进封装定义
以系统应用为出发点,各种技术进行异质整合的先进封装技术持续演进
先进封装也称为高密度先进封装HDAP(High Density Advanced Package)。
采用了先进的设计思路和先进的集成工艺、缩短引线互连长度,对芯片进行系统级封装的重构,并且能有效提高系统功能密度的封装。
现阶段的先进封装是指:倒装焊(FlipChip)、晶圆级封装(WLP)、2.5D封装(Interposer、RDL)、3D封装(TSV)
2009
2014
2020
Future
复杂度不断上升
晶圆级封装
(WLP)
移动处理器
CPU/GPU
射频封装
汽车电子
封装
�







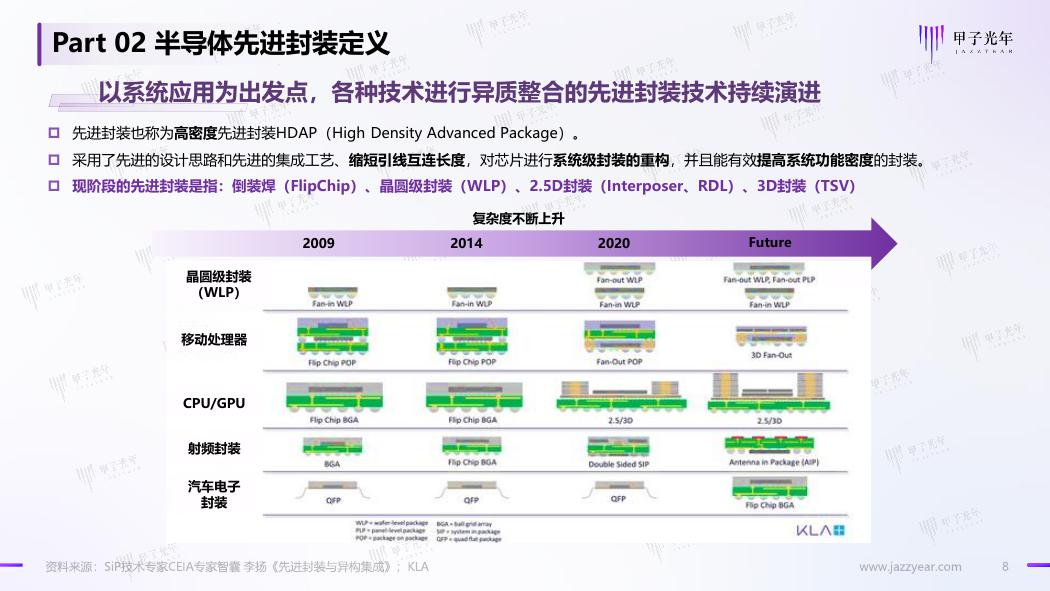







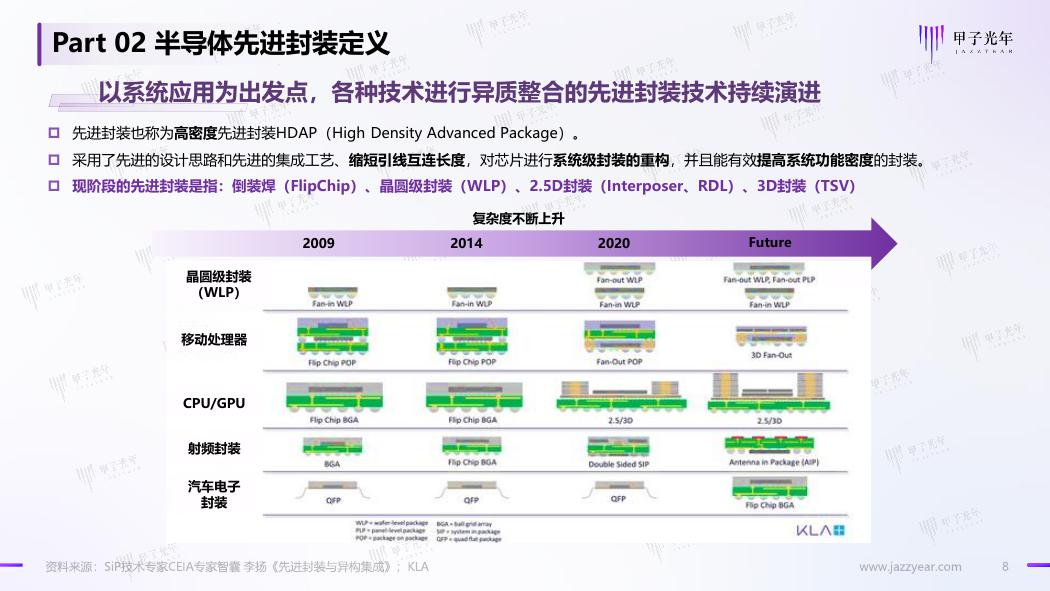
 V2版本原理图(Capacitive-Fingerprint-Reader-Schematic_V2).pdf
V2版本原理图(Capacitive-Fingerprint-Reader-Schematic_V2).pdf 摄像头工作原理.doc
摄像头工作原理.doc VL53L0X简要说明(En.FLVL53L00216).pdf
VL53L0X简要说明(En.FLVL53L00216).pdf 原理图(DVK720-Schematic).pdf
原理图(DVK720-Schematic).pdf 原理图(Pico-Clock-Green-Schdoc).pdf
原理图(Pico-Clock-Green-Schdoc).pdf 原理图(RS485-CAN-HAT-B-schematic).pdf
原理图(RS485-CAN-HAT-B-schematic).pdf File:SIM7500_SIM7600_SIM7800 Series_SSL_Application Note_V2.00.pdf
File:SIM7500_SIM7600_SIM7800 Series_SSL_Application Note_V2.00.pdf ADS1263(Ads1262).pdf
ADS1263(Ads1262).pdf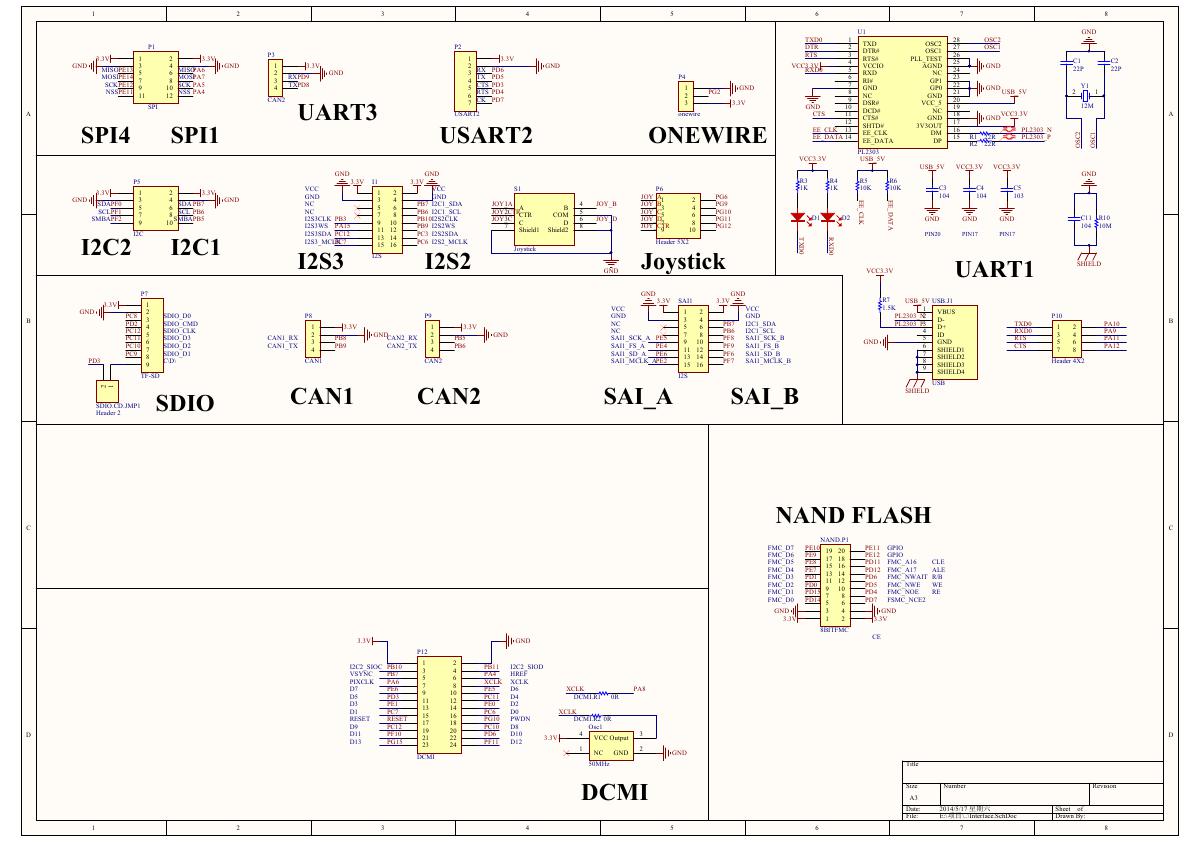 原理图(Open429Z-D-Schematic).pdf
原理图(Open429Z-D-Schematic).pdf 用户手册(Capacitive_Fingerprint_Reader_User_Manual_CN).pdf
用户手册(Capacitive_Fingerprint_Reader_User_Manual_CN).pdf CY7C68013A(英文版)(CY7C68013A).pdf
CY7C68013A(英文版)(CY7C68013A).pdf TechnicalReference_Dem.pdf
TechnicalReference_Dem.pdf