Your ONE STOP solutions provider
集成电路先进封装SiP发展趋势
俞国庆
2019/3/
�
Service
服 务
Innovation
创 新
Enterprising
进 取
Harmonious
和 谐
TONGFU MICROELECTRONICS
内容
n 通富微电简介
n 摩尔定律的挑战和解决方案
n 解决方案比较
n 先进封装发展roadmap
www.tfme.com
�
Service
服 务
Innovation
创 新
Enterprising
进 取
Harmonious
和 谐
TONGFU MICROELECTRONICS
通富微电(TFME)概览
u 1997年成立
u 2007年深圳上市
u 2017年全球封测企业排名第六
u 集团员工12000人
u 全球六大生产基地,其中厦门在建
u 提供传统和先进封测一站式服务
TFME (HQ)
Nantong Jiangsu
Nantong Sutong
Nantong Jiangsu
Hefei Tongfu
Hefei Anhui
TF-AMD Png
Penang Malaysia
TF-AMD Suz
Suzhou Jiangsu
- Bumping
- WLCSP
- BGAs, LGAs, FCCSP
- QFNs, QFPs, ICs
- Power Packaging
- Discrete Packaging
- Test services
- BGAs
- LGAs
- FCCSP, BGAs, QFN
- Test services
-ICs (High Density)
-LCD Driver
- Descrete Packaging
- Test services
- FCBGAs
- FCLGAs
- FCPGAs
- Coreless BGAs
- Test services
- FCBGAs
- FCLGAs
- FCPGAs
- Coreless BGAs
- Test services
www.tfme.com
�
Service
服 务
Innovation
创 新
Enterprising
进 取
Harmonious
和 谐
TONGFU MICROELECTRONICS
Mass production already
WLCSP forms
FC-based package
2P2M
2P1M
1P1M
FCBGA
FCCSP
FCQFN
Cu pillar
Fan-in WLCSP
Wafer bumping (Cu pillar, Au bump)
+ FC-based package
www.tfme.com
TFME先进封装技术一览
Ready in 2019
FOPoS
Due die FO
H
B
M
H
B
M
Logic IC
single die FO
Fan-out WLCSP
2.5D package
�
Service
服 务
Innovation
创 新
Enterprising
进 取
Harmonious
和 谐
TONGFU MICROELECTRONICS
内容
n 通富微电简介
n 摩尔定律的挑战和解决方案
n 解决方案比较
n 先进封装发展roadmap
www.tfme.com
�
Service
服 务
Innovation
创 新
Enterprising
进 取
Harmonious
和 谐
TONGFU MICROELECTRONICS
摩尔定律:从芯片制造角度,继续按特征尺寸微缩规律对逻辑芯片、Memory、CPU提高SoC集成度;但持续微缩新工艺(5nm以下?)带来
物理学挑战:量子效应(如量子隧穿效应导致晶体管漏电)和光刻精度,以及经济学挑战:芯片性价比下降
半导体行业MM & MtM定律的挑战
Beyond CMOS:在硅基CMOS
遇到物理极限时所能倚重的新
型器件
SoC和SiP的结合
www.tfme.com
超越摩尔定律:从系统级封装(SiP)
角度,把模拟/射频、功率、传感器、被动
元件等封装在一体,进行功能和系统集成
�
Service
服 务
Innovation
创 新
Enterprising
进 取
Harmonious
和 谐
TONGFU MICROELECTRONICS
chip1
…
Chip n
WB SiP
chip1
…
Chip n
FC SiP
…
WB+FC hybrid SiP
…
???SiP
??? SiP
系统芯片SoC和系统级封装SiP比较
Time to market , NRE
不同前道技术(非硅材料)和
工艺节点,甚至被动元件整合
单芯片良率
设计工具充足
性能
SiP
J
J
J
L
L
SoC
L
L
L
J
J
???SiP需要解决WB SiP, FC SiP等问题
1. 由于芯片输入端到基板输出端long transmission distance
引起功耗
2. 由于芯片之间long interconnection,性能变差
3. 由于基板routing constraint, 封装large form factor
splits &
reconstitutes
in SiP
SoC
SoC in FCBGA
www.tfme.com
�
Service
服 务
Innovation
创 新
Enterprising
进 取
Harmonious
和 谐
TONGFU MICROELECTRONICS
内容
n 通富微电简介
n 摩尔定律的挑战和解决方案
n 解决方案比较
n 先进封装发展roadmap
www.tfme.com
�



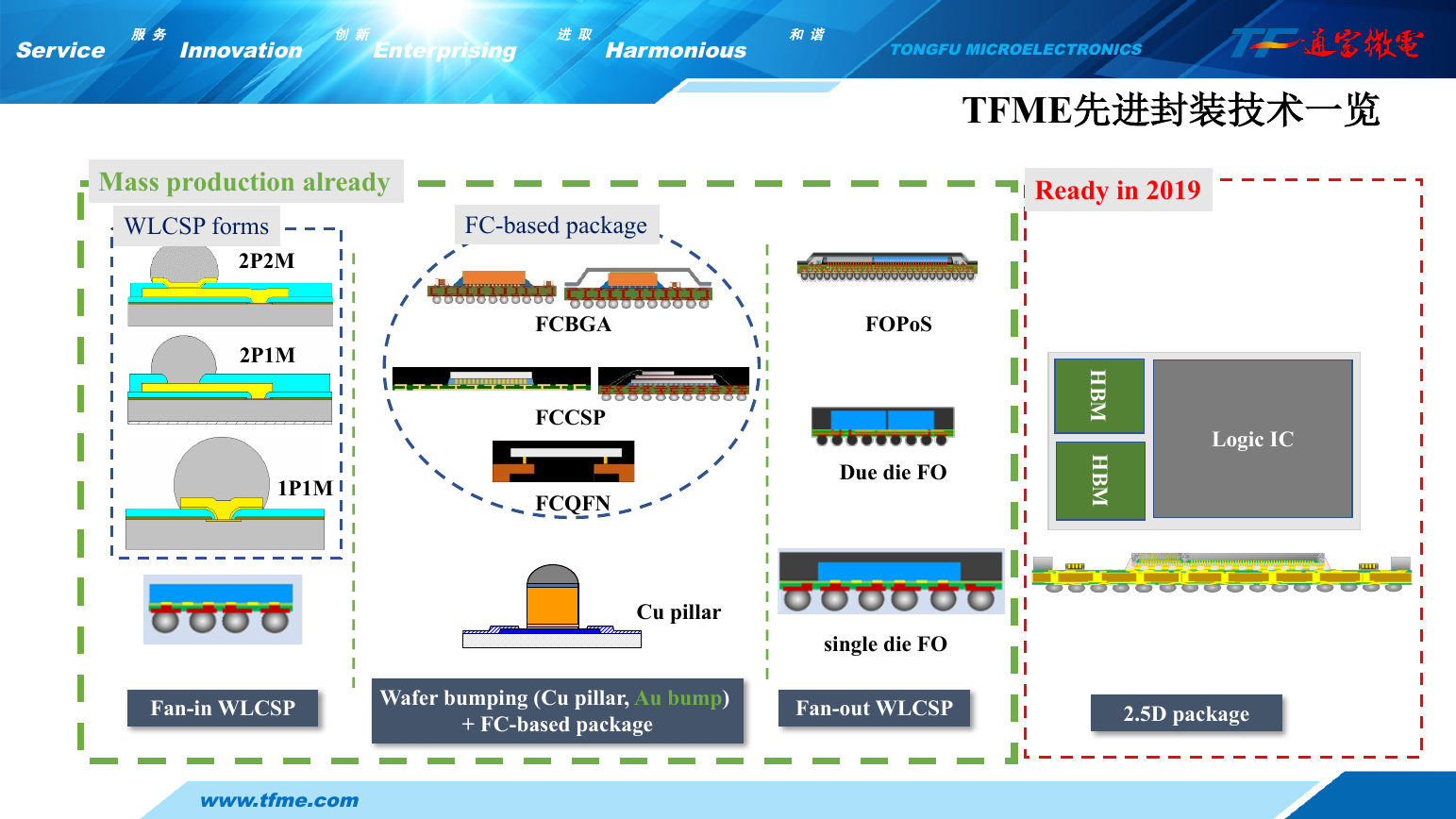

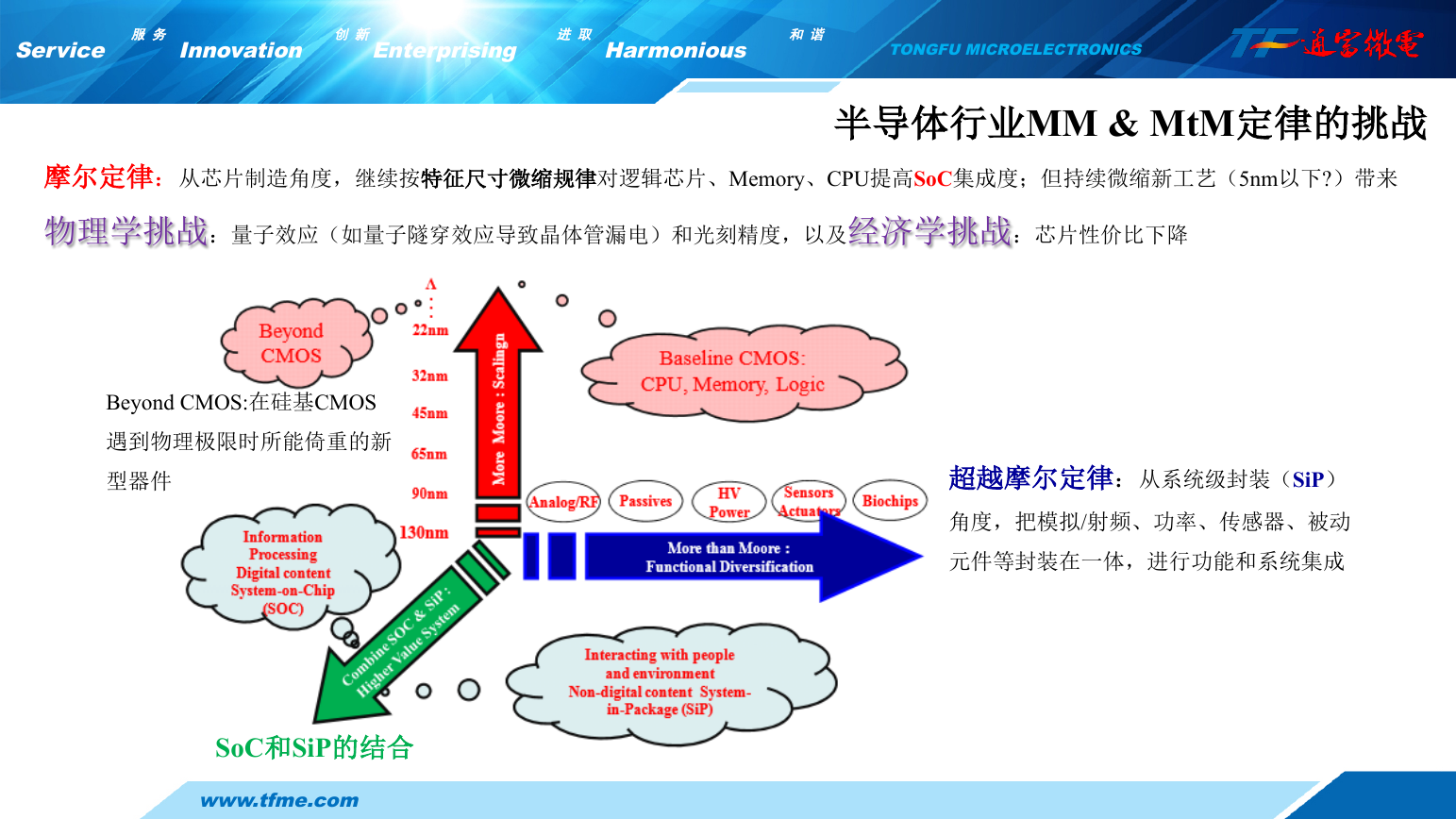
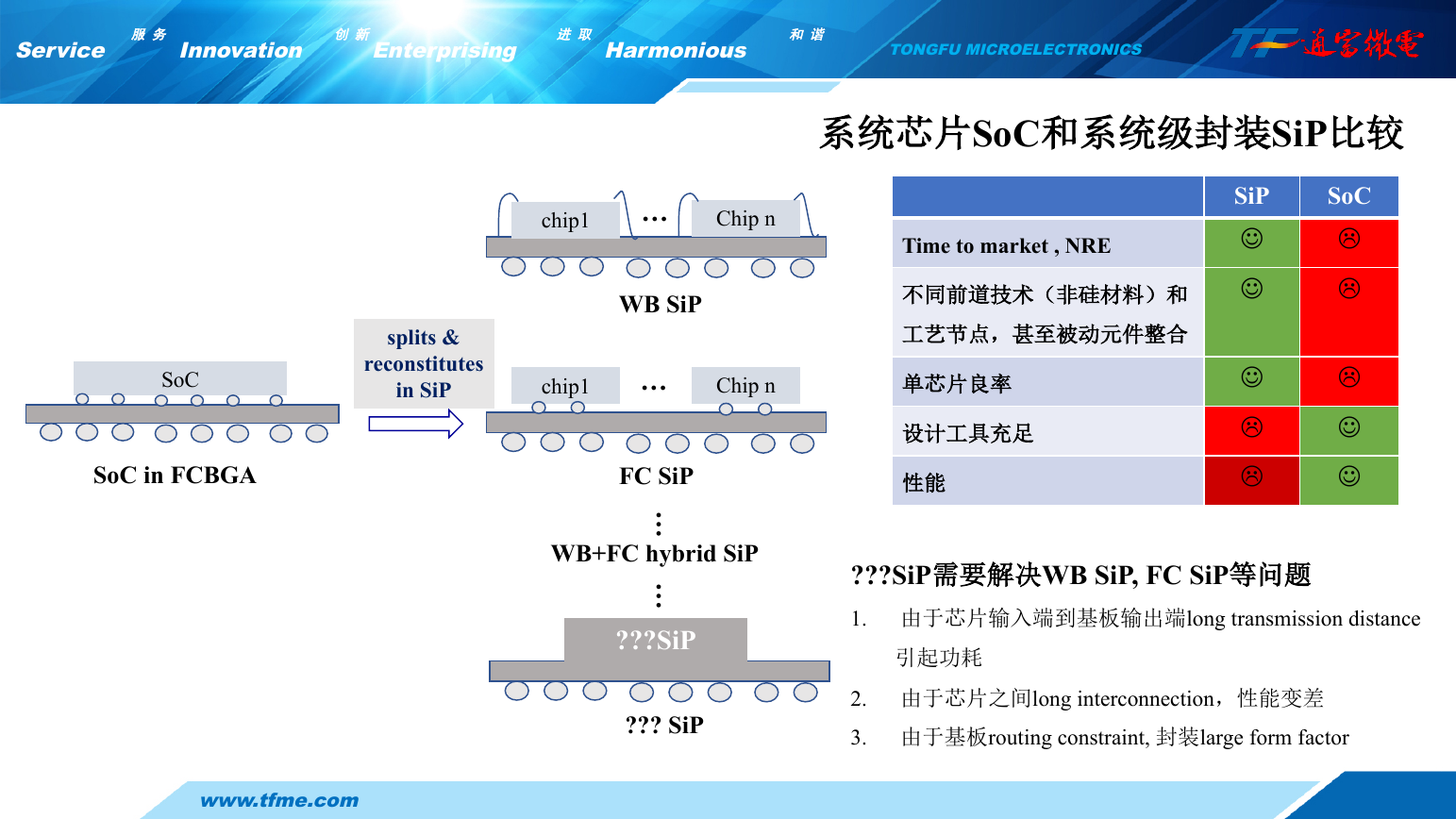




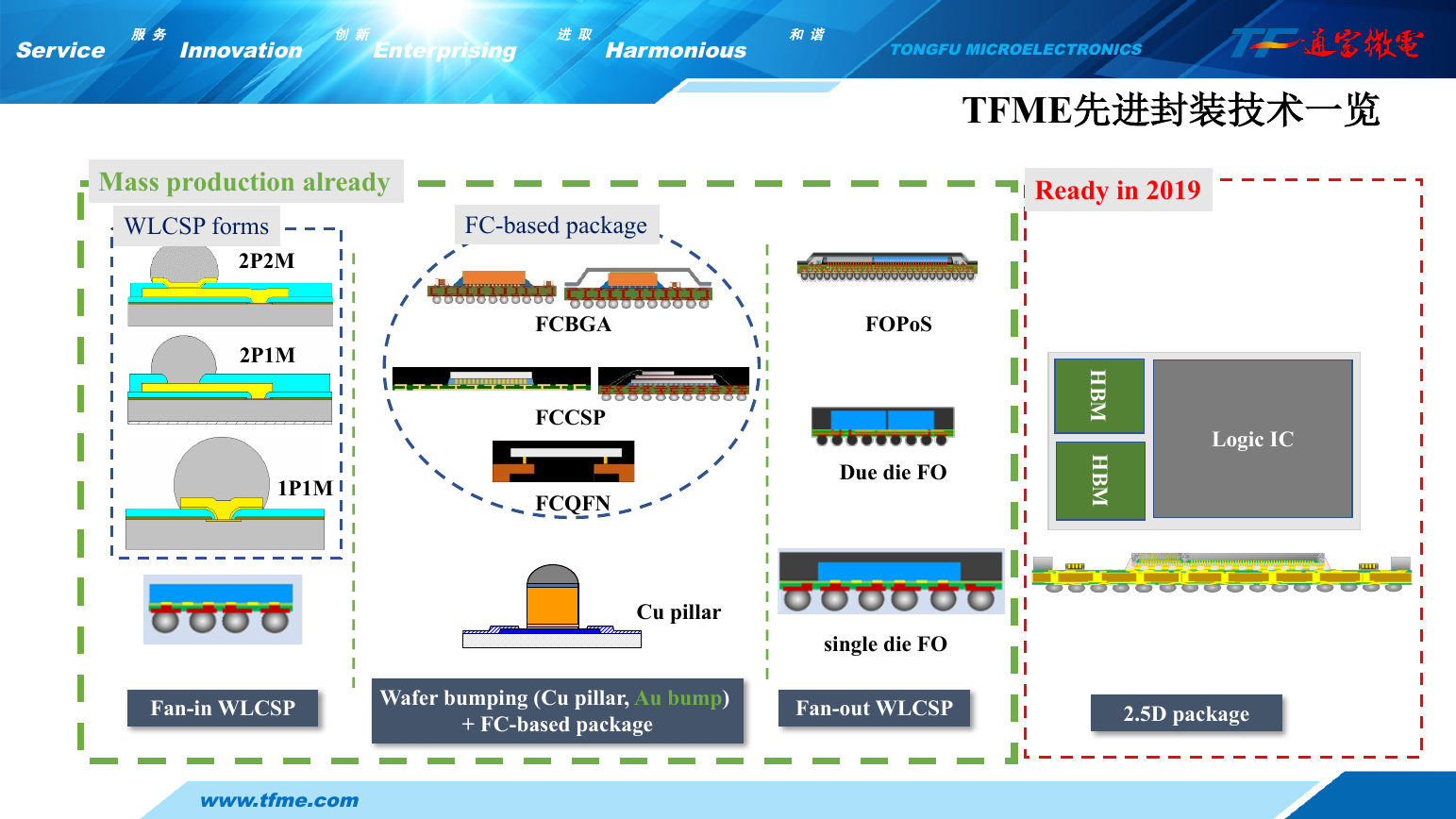

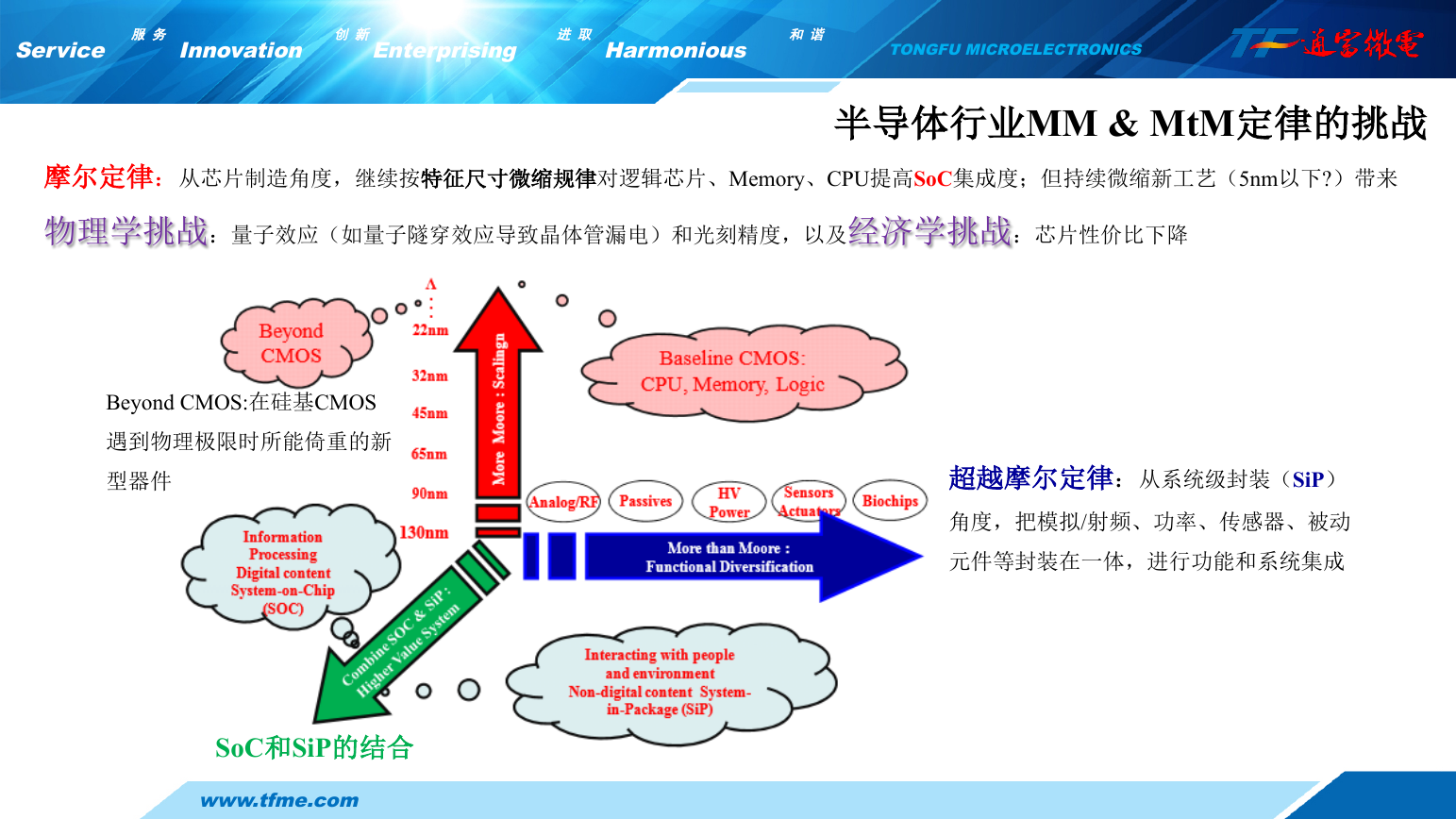
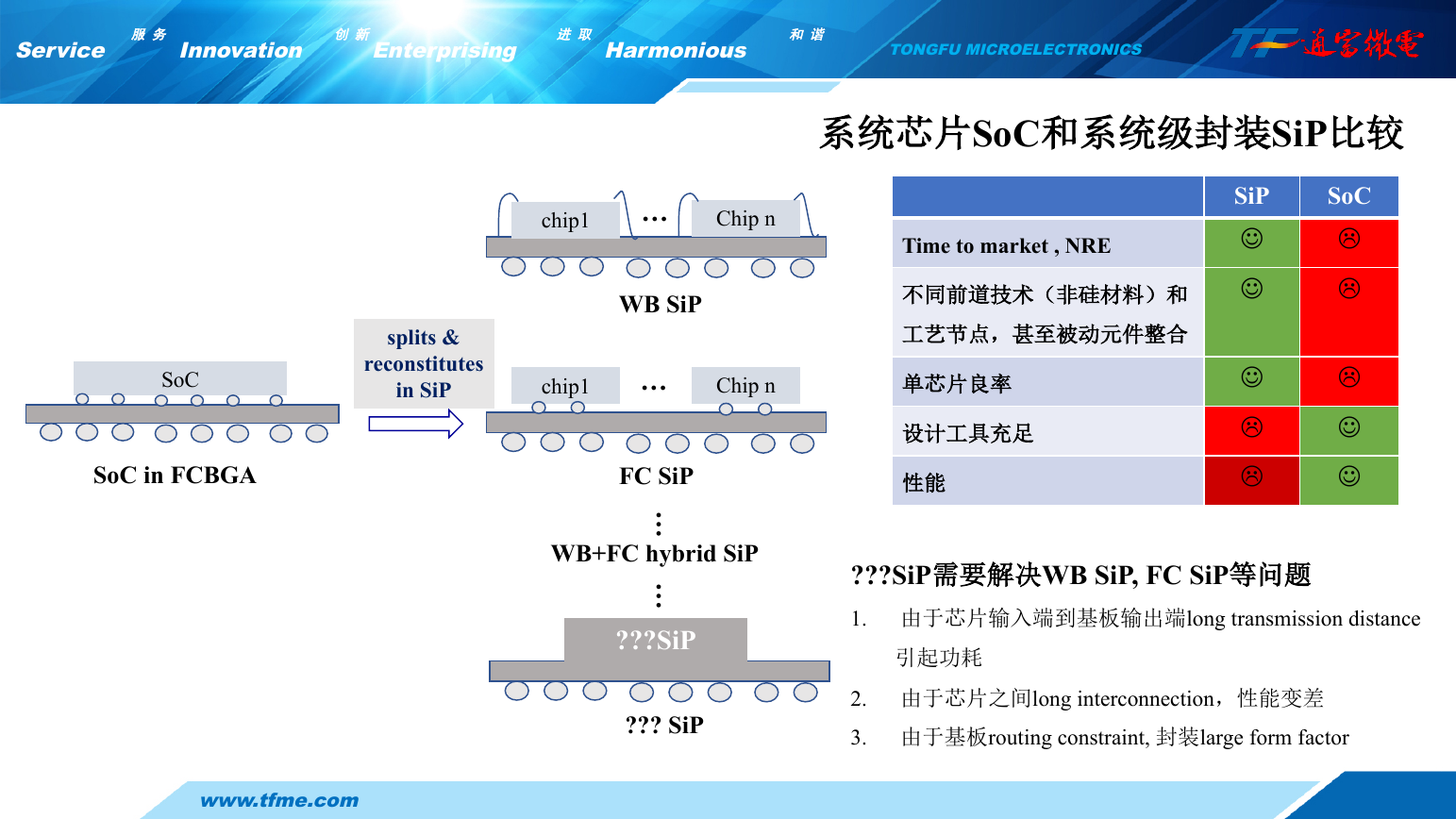

 2023年江西萍乡中考道德与法治真题及答案.doc
2023年江西萍乡中考道德与法治真题及答案.doc 2012年重庆南川中考生物真题及答案.doc
2012年重庆南川中考生物真题及答案.doc 2013年江西师范大学地理学综合及文艺理论基础考研真题.doc
2013年江西师范大学地理学综合及文艺理论基础考研真题.doc 2020年四川甘孜小升初语文真题及答案I卷.doc
2020年四川甘孜小升初语文真题及答案I卷.doc 2020年注册岩土工程师专业基础考试真题及答案.doc
2020年注册岩土工程师专业基础考试真题及答案.doc 2023-2024学年福建省厦门市九年级上学期数学月考试题及答案.doc
2023-2024学年福建省厦门市九年级上学期数学月考试题及答案.doc 2021-2022学年辽宁省沈阳市大东区九年级上学期语文期末试题及答案.doc
2021-2022学年辽宁省沈阳市大东区九年级上学期语文期末试题及答案.doc 2022-2023学年北京东城区初三第一学期物理期末试卷及答案.doc
2022-2023学年北京东城区初三第一学期物理期末试卷及答案.doc 2018上半年江西教师资格初中地理学科知识与教学能力真题及答案.doc
2018上半年江西教师资格初中地理学科知识与教学能力真题及答案.doc 2012年河北国家公务员申论考试真题及答案-省级.doc
2012年河北国家公务员申论考试真题及答案-省级.doc 2020-2021学年江苏省扬州市江都区邵樊片九年级上学期数学第一次质量检测试题及答案.doc
2020-2021学年江苏省扬州市江都区邵樊片九年级上学期数学第一次质量检测试题及答案.doc 2022下半年黑龙江教师资格证中学综合素质真题及答案.doc
2022下半年黑龙江教师资格证中学综合素质真题及答案.doc