集成电路常用器件介绍
一、CMOS 工艺下器件:
CMOS 工艺可分为 P 阱 CMOS、N 阱 CMOS 和双阱 CMOS。以 NWELL 工艺为例说明 CMOS 中常用有源及无源器件
的器件结构、工作原理、特性参数等。建议在此之前先了解 CMOS 的基本工艺。
1.1 有源器件
1. MOS 管 采用 N 阱工艺制作的 PMOS 与 NMOS 结构示意图如图(1.1-1),在衬底为轻掺杂 P-的材料上,
扩散两个重掺杂的 N+区就构成了 N 沟器件,两个 N+区即源漏,中间为沟道。中间区域的表面上有以薄层介质
材料二氧化硅将栅极(多晶硅)与硅隔离开。同样,P 沟器件是在衬底为轻掺杂的 N-的材料(即 N 阱或 NWELL)
上,扩散两个重掺杂的 P+区形成的。
图中的 B 端是指衬底,采用 N 阱工艺时,N 阱接最高电位 VDD,Psub 接 VSS。通常将 PMOS、NMOS 的源极与衬
底接在一起使用。这样,栅极和衬底各相当于一个极板,中间是二氧化硅绝缘层,形成电容。当栅源电压变
化时,将改变衬底靠近绝缘层处感应电荷的多少,从而控制漏极电流的大小。
图(1.1-1)
�
以 N 沟器件为例说明 MOS 管的工作原理:
(1)N 沟增强型 MOS 管:当栅源之间不加电压时,漏源之间是两只背靠背的 PN 结,不存在导电沟道,
因此即使漏源之间加电压,也不会有漏极电流。
当 uDS=0,且 uGS>0 时,由于二氧化硅的存在,栅极电流为零。但是栅极金属层将聚集正电荷,它们排
斥 P 型衬底靠近二氧化硅一侧的空穴,使之剩下不能移动的负离子区,形成耗尽层。当 uGS 增大,一方面耗尽
层加宽,另一方面将衬底的自由电子吸引到耗尽层于绝缘层之间,形成一个 N 型薄层,称为反型层,如图
(1.1-2)。这个反型层即源漏之间的导电沟道。指沟道刚刚形成的栅源电压称为开启电压 UGS(th)。uGS 越大反型
层越厚,导电沟道电阻越小。
图(1.1-2)
当 uGS 是大于 UGS(th)的一个确定值时,若在漏源之间加正向电压,则产生一定的漏极电流。此时,uDS
的变化对导电沟道的影响与结型场效应管相似,即当 uDS 较小时,uDS 的增大使漏极电流线性增大,沟道沿源漏
方向逐渐变窄,一旦 uDS 增大到使 uGD= UGS(th)[即 uDS=UGS- UGS(th)]时,沟道在漏极一侧出现夹断点,称为预夹断,
如图(1.1-3)所示。如果 uDS 继续增大,夹断区随之延长。而且 uDS 的增大大部分几乎用于克服夹断区对漏极电
流的阻力。从外部看,漏极电流几乎不因 uDS 的增大而变化,管子进入恒流区,漏极电流几乎仅决定于 uGS。
图(1.1-3)
�
(2)N 沟耗尽型 MOS 管:如果在制造 MOS 管时,在二氧化硅绝缘层中掺入大量正离子(或者在衬底沟
道区注入与衬底相反类型的离子),那么即使 uGS=0,在正离子的作用下 P 型衬底表面也存在反型层,即漏源
之间存在导电沟道,只要在源漏之间加正向电压,就会产生漏极电流。且 uGS 为正时,反型层加宽,漏极电流
加大,反之漏极电流减小。当 uGS 从零减小到一定值时,反型层消失,漏极电流为零。此时的 uGS 称为夹断电
压 uGS(off)。如图(1.1-4)
图(1.1-4)N 耗尽管
2.三极管 (VPNP 、 LPNP、VNPN)
CMOS 工艺下可以做双极晶体管,但是集电极要受到限制(必须接至 VDD 或 VSS),以 N 阱工艺为例说明其
VPNP,VNPN 如何形成。如图(1.1-6),VNPN 即衬底 PNP 的发射极是与源漏扩散同时形成的,基极是与阱同时
形成的,P-衬底是集电极,P-衬底接最负电位,所以基极与集电极形成反相 PN 结。其晶体管的作用发生在纵
向,所以也叫纵向 PNP。因基区是阱,所以基区电阻较大。
在基本 N 阱 CMOS 工艺的基础上再加一道工序,即在源漏扩散前加一掺杂的 P 型扩散层 BP,就可以制作
�
纵向 NPN 管,即 VNPN。如图(1.1-7)。而 CMOS 工艺下的 LPNP 存在两个寄生 PNP 管,通常短接两端应用于
ESD 保护。如图(1.1-8)。
图(1.1-6)
图(1.1-7)
�
图(1.1-8)左边为版图,右边为其剖面图
3.二极管(psub-nwell、sp-nwell)
CMOS N 阱工艺中二极管结构有两种,一是 psub-nwell,另一个是 sp-nwell,其中 SP 即 P+重掺杂,在源
漏扩散时形成。SP/N-WELL 二极管存在寄生 PNP 三极管和较大的串联电阻。
�
1.2 无源器件
1.CAP
CMOS 工艺中除了,MOS 电容外,可与之兼容的还有 BN 电容和双 POLY 电容。下面分别介绍其结构和特性。
(1)MOS 电容 也叫感应沟道的单层多晶硅 MOS 电容器,此电容器结构如图(1.2-1),它是以栅氧
化层作为介质,多晶硅为上极板,衬底为下极板。
图(1.2-1)
(2)BN 电容 这是一种以多晶硅作为上极板,栅氧化层为介质,BN 层为下极板的电容器。其中 BN 层是
与源漏掺杂差不多的一种重掺杂。从工艺来看,源漏的扩散是在多晶硅淀积和定域之后做的,所以要在此时
为电容做重掺杂是不可能的,必须在淀积多晶硅之前加一道工序作为下极板。在自厂 CMOS 工艺的标准层中,
BN 为第五层,POLY 为第七层。在 CMOS N 阱工艺中 BN 电容经常做在 NWELL 里,NWELL 可以在这里起抗压和隔
离噪声的作用。此种电容约为 0.35-0.5fF/um2。其版图和剖面图如图(1.2-2)
�
图(1.2-2)
图(1.2-3)
(3)双 POLY 电容 双 POLY 电容由两个导电层(金属或多晶硅)构成,中间用二氧化硅隔开。通常是
多晶硅-二氧化硅-多晶硅结构。如图(1.2-3)所示。做这种电容需要两次多晶硅工艺,比单层多晶硅要多
几道工序。双 POLY 电容是做在场氧化层上,电容的上下极通过场氧化层与其他器件及衬底隔开,是个寄生参
量很小的固定电容。只要能精确控制所生长的氧化层介质的质量和厚度,就可以得到精确的电容值。其单位
电容的典型值为 0.3~0.4fF/um2。此数值较小是因为其二氧化硅的厚度比栅氧化层的厚度要大些。
以上介绍的这些电容都存在不可避免的寄生电容,如双 POLY 电容的上极板与上层的互连线,下极板与衬
底。而这些寄生电容通常与电容自身的大小,版图形状,工艺参数有关。可以通过版图设计,工艺控制尽可
能减小。
2.电阻
在能与 CMOS 工艺兼容的电阻通常有四种:扩散电阻、多晶硅电阻、阱电阻、夹断电阻。下面分别介绍:
(1)扩散电阻 扩散电阻是在源漏扩散时形成,有 N+扩散和 P+扩散电阻。在 CMOS 工艺下,N+扩散电
阻是做在 PSUB 上,P+扩散是在 N 阱里,如图(1.2-4)。这类电阻器的阻值估算为
R=RSL/W
RS 为薄层电阻,L,W 分别为电阻器的宽度和长度。实际的电阻的版图形状根据电阻的大小,设计会有不
同,所以计算方法也比较复杂,例如做大电阻时有拐角,那拐角处的电阻必须乘以拐角修正因子(k=0.5)。
RS 的阻值范围为 10-100 欧/方。N+扩散电阻的 RS 值通常小于 P+扩散电阻,以自厂为例,N+扩散电阻的 RS
为 50 欧,P+扩散电阻的 RS 为 100 欧。方块值越大,其温度系数越大;其特征尺寸越小,浓度越高。
�
图(1.2-4)
(2)多晶硅电阻 多晶硅电阻结构较简单如图(1.2-5)所示,左边是以 POLY1 做电阻时的版图与剖面图,
右边是 POLY2 做电阻时的版图与剖面图,POLY2 电阻在端头处多加了 N+注入,时为了降低端头接触电阻。但
是如果要求电阻精确匹配的话,最好整个电阻区域都覆盖 N+。(模拟版图的艺术 P178)。POLY 电阻要做在场
氧上,不仅可以减小电阻与衬底间的寄生电容,也可以确保电阻值不会因为薄氧的台阶而引起不可预料的变
化。其薄层电阻通常在 30—200 欧/方范围内,做低阻时 25-50 欧/方。由于电路设计的需要,还经常通过工
艺掺杂手段的不同来调整出不同薄层电阻值的多晶硅电阻。例如,用扩散掺杂法制作的这类电阻精度就不高,
主要用来作存储器单元的负载电阻,它要求高阻值的同时可放松对精度的要求。而用离子注入法掺杂工艺时,
电阻的精度较高。
图(1.2-5)左边为 poly1 电阻,右边为 POLY2 电阻
�
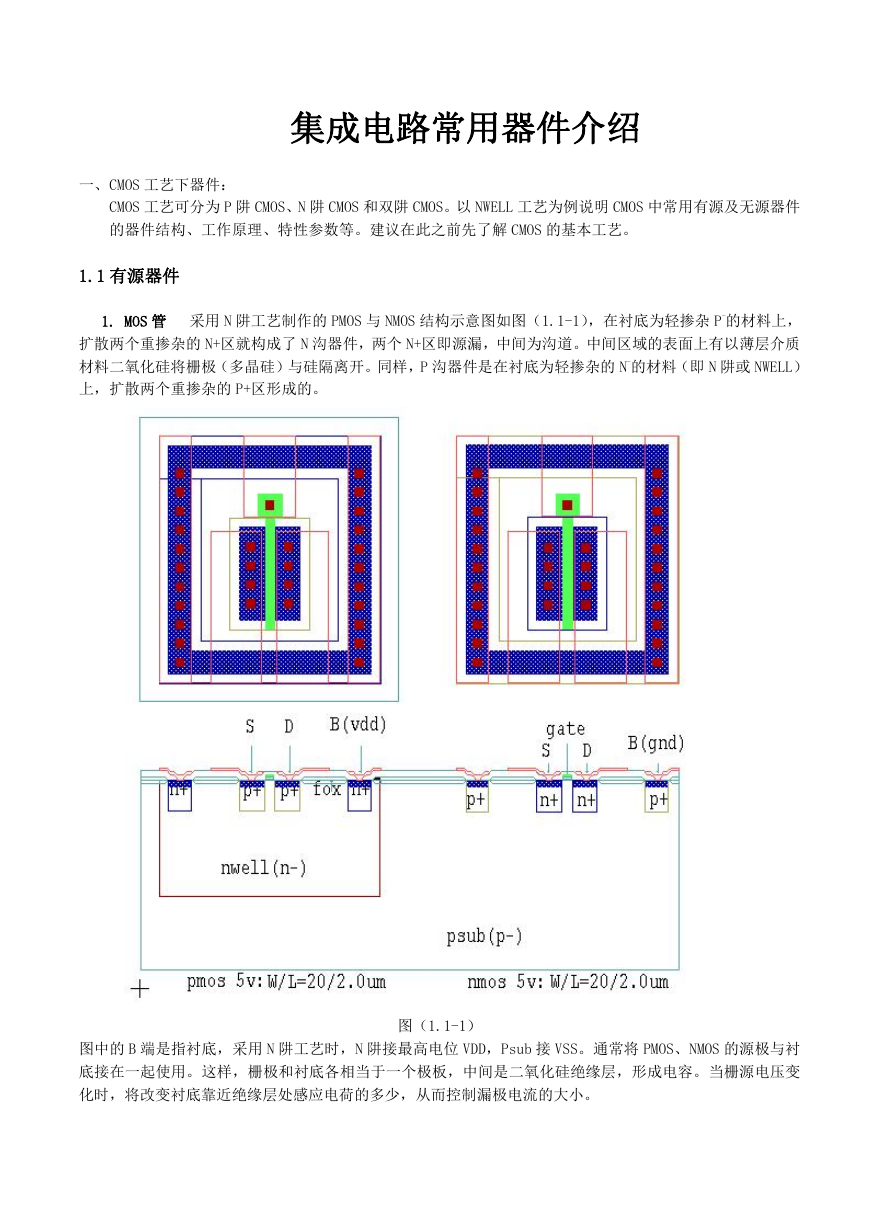
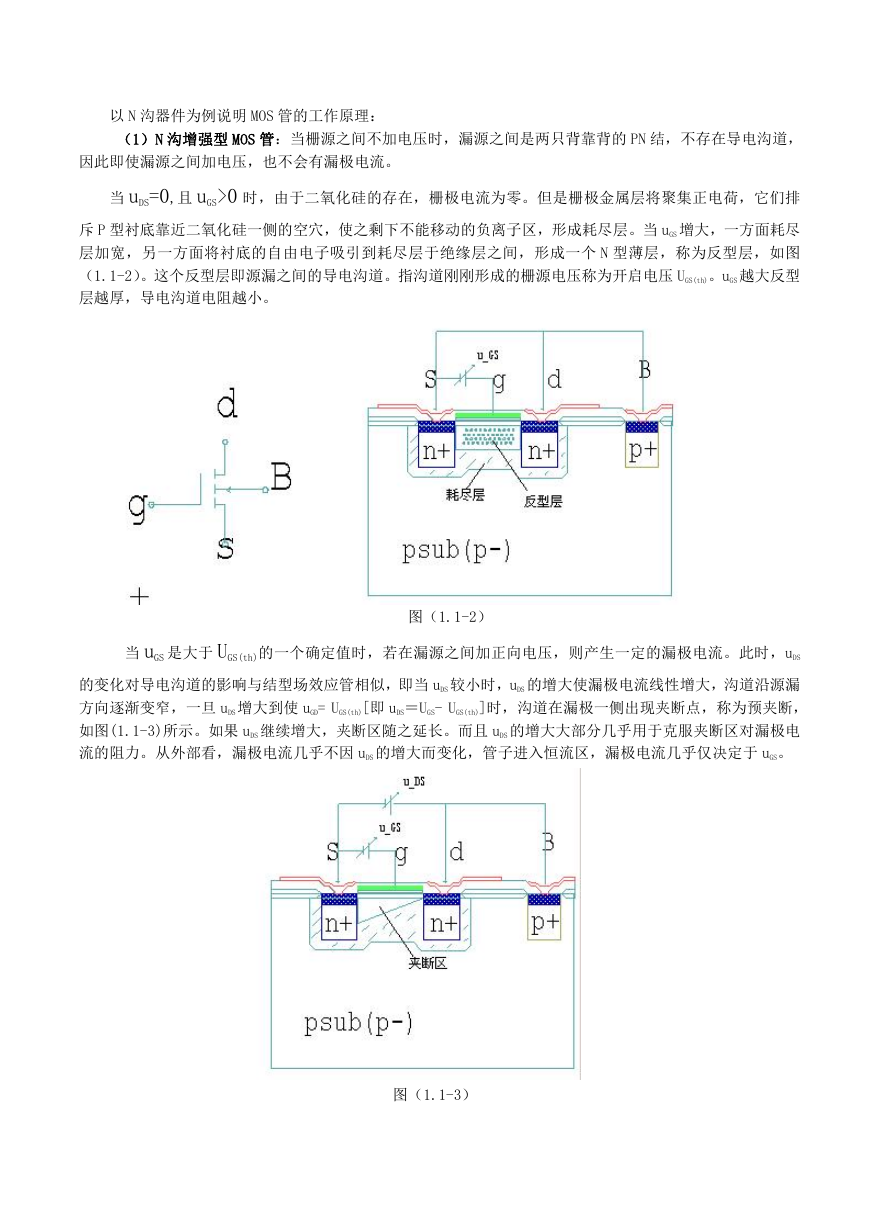


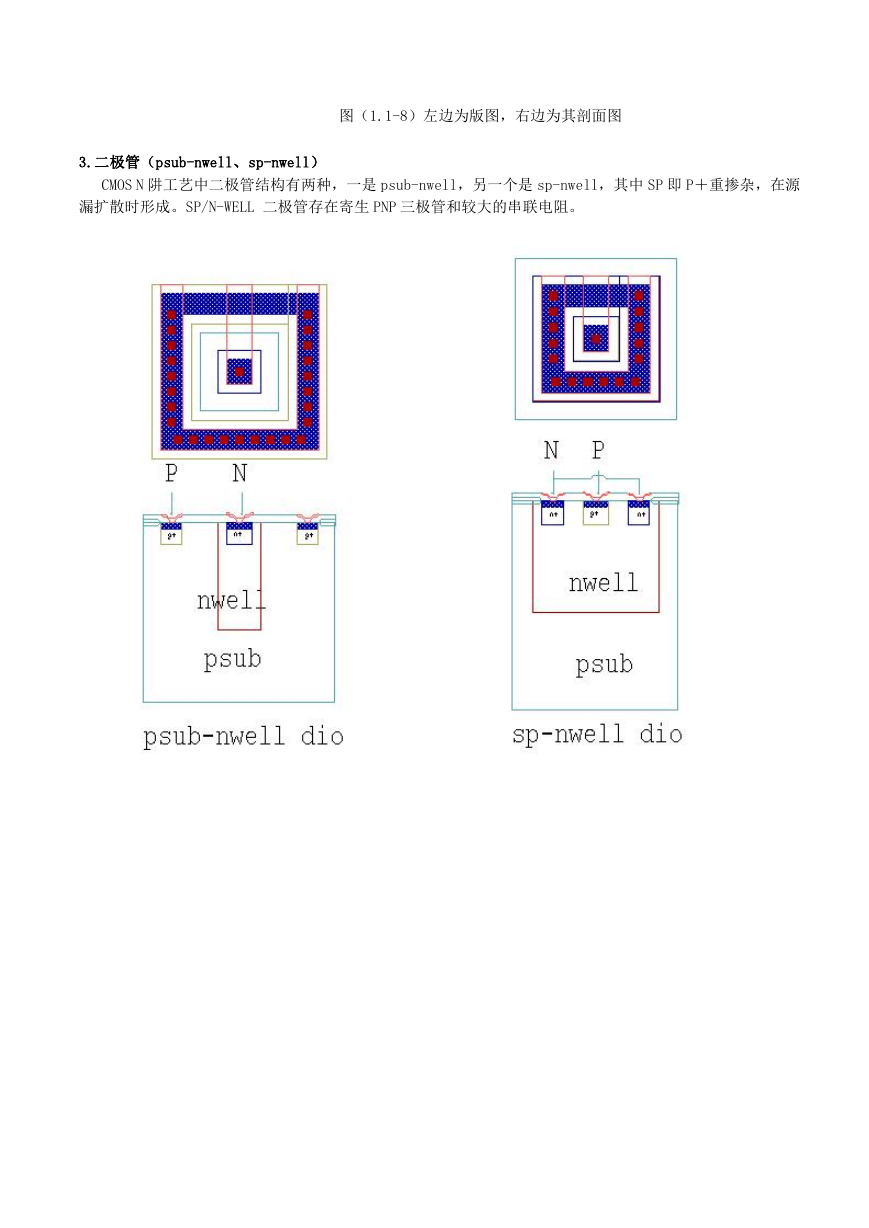
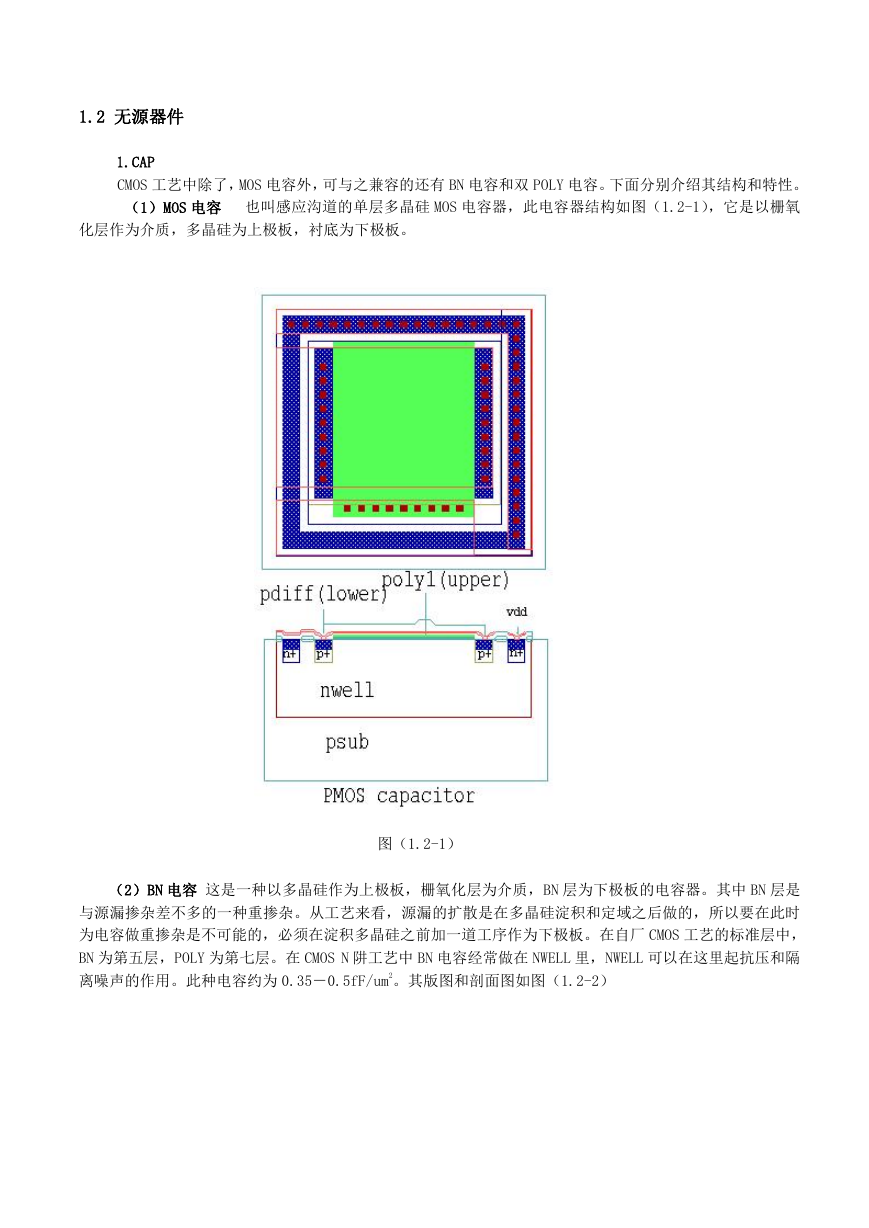
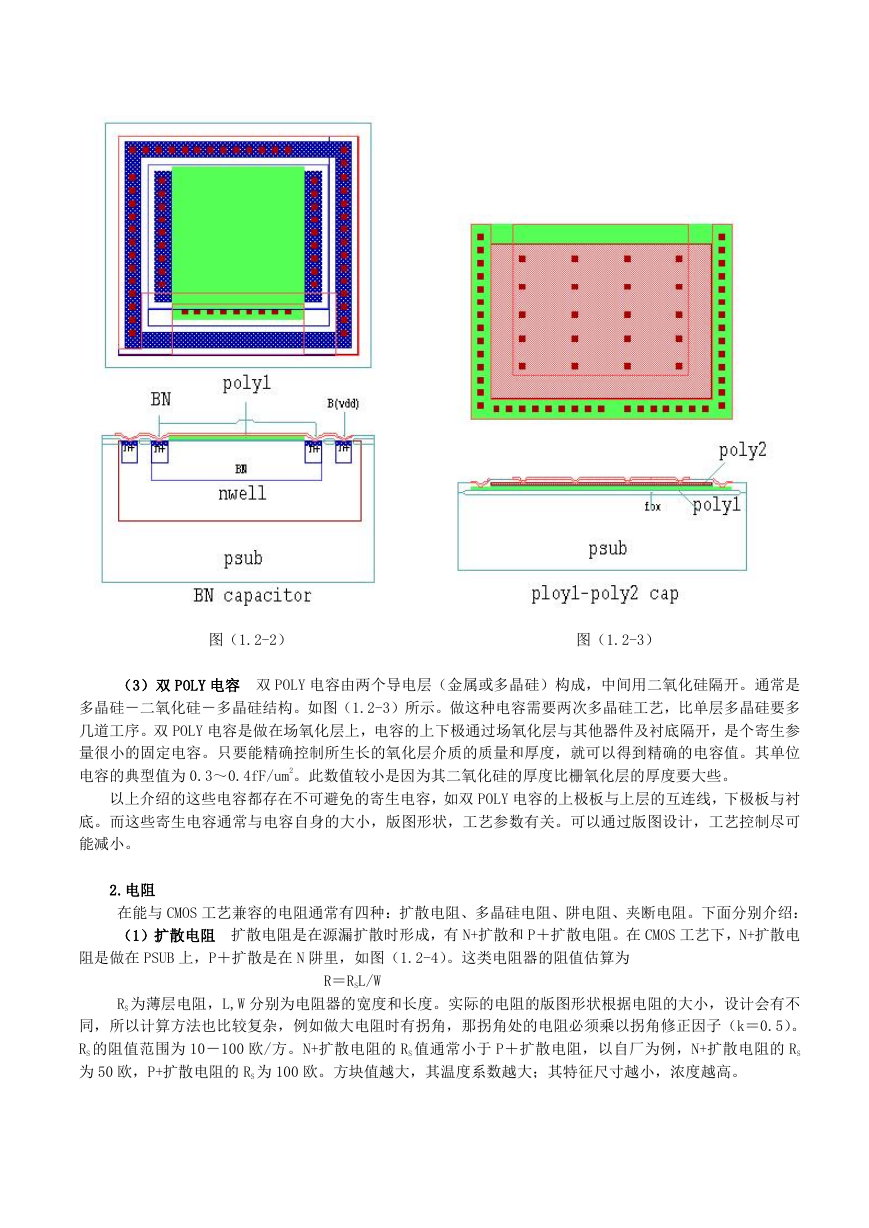
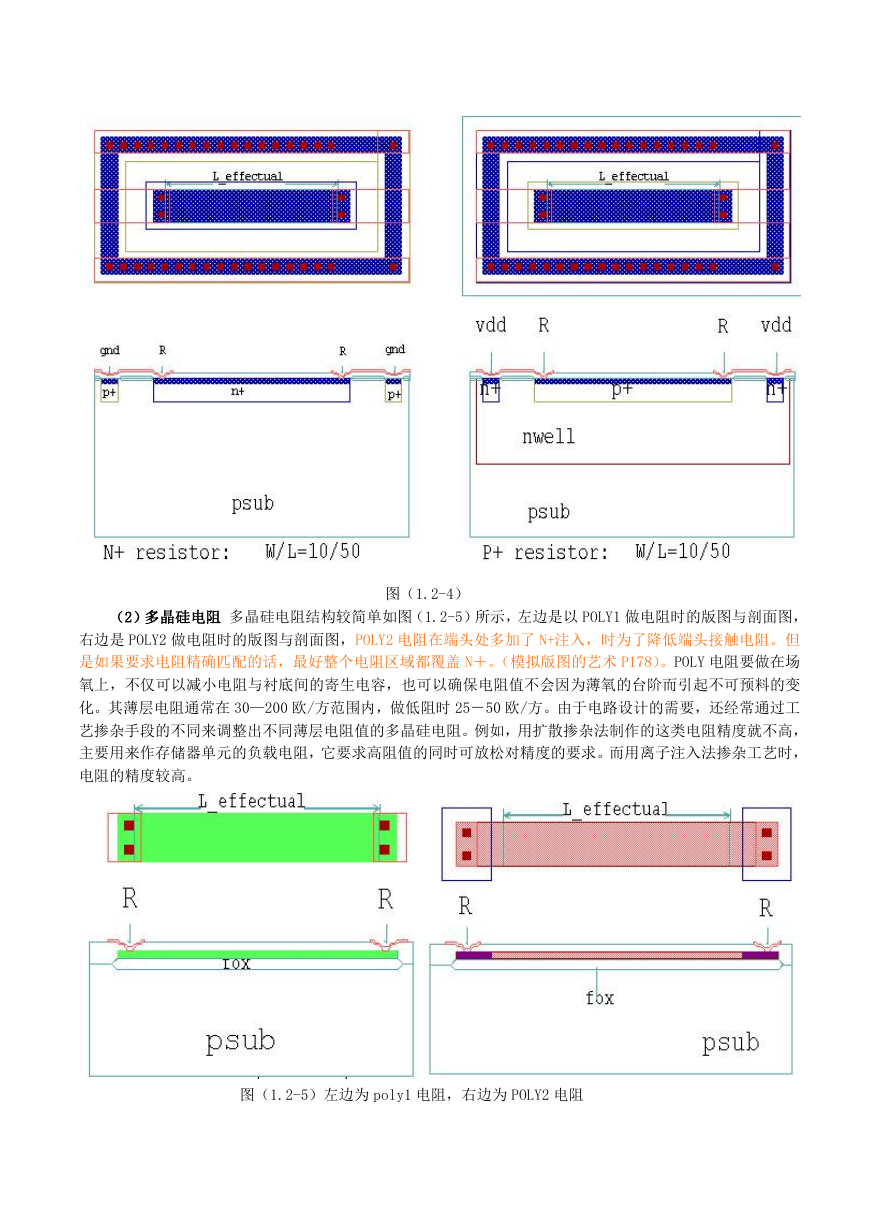
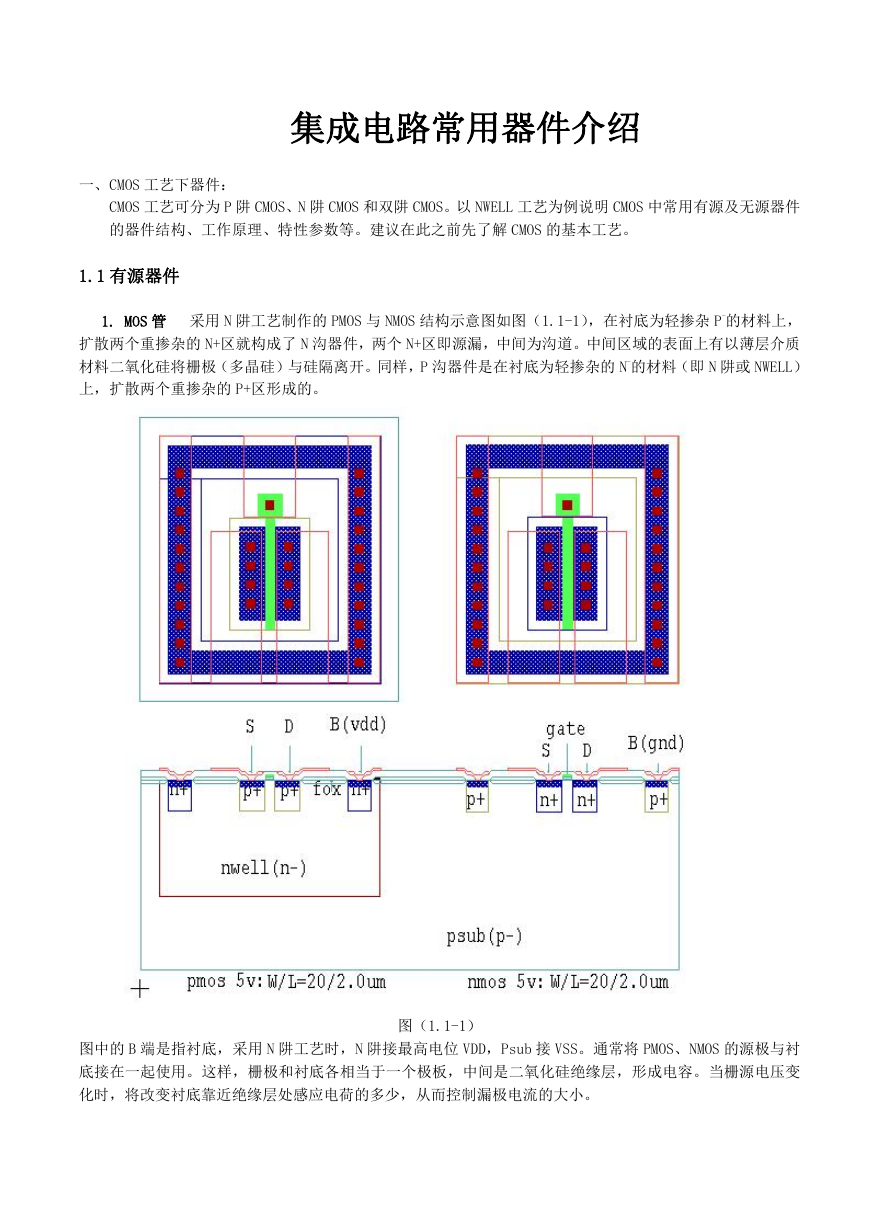
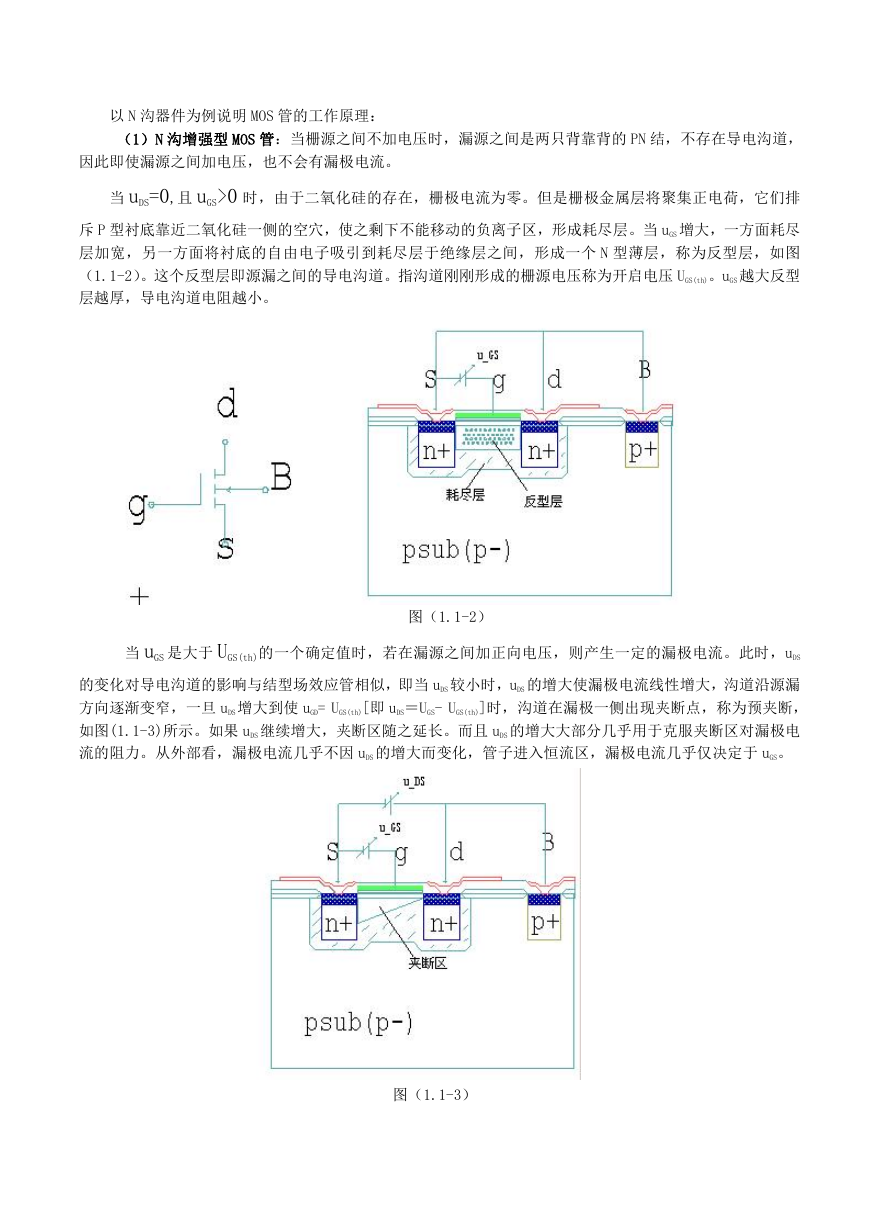


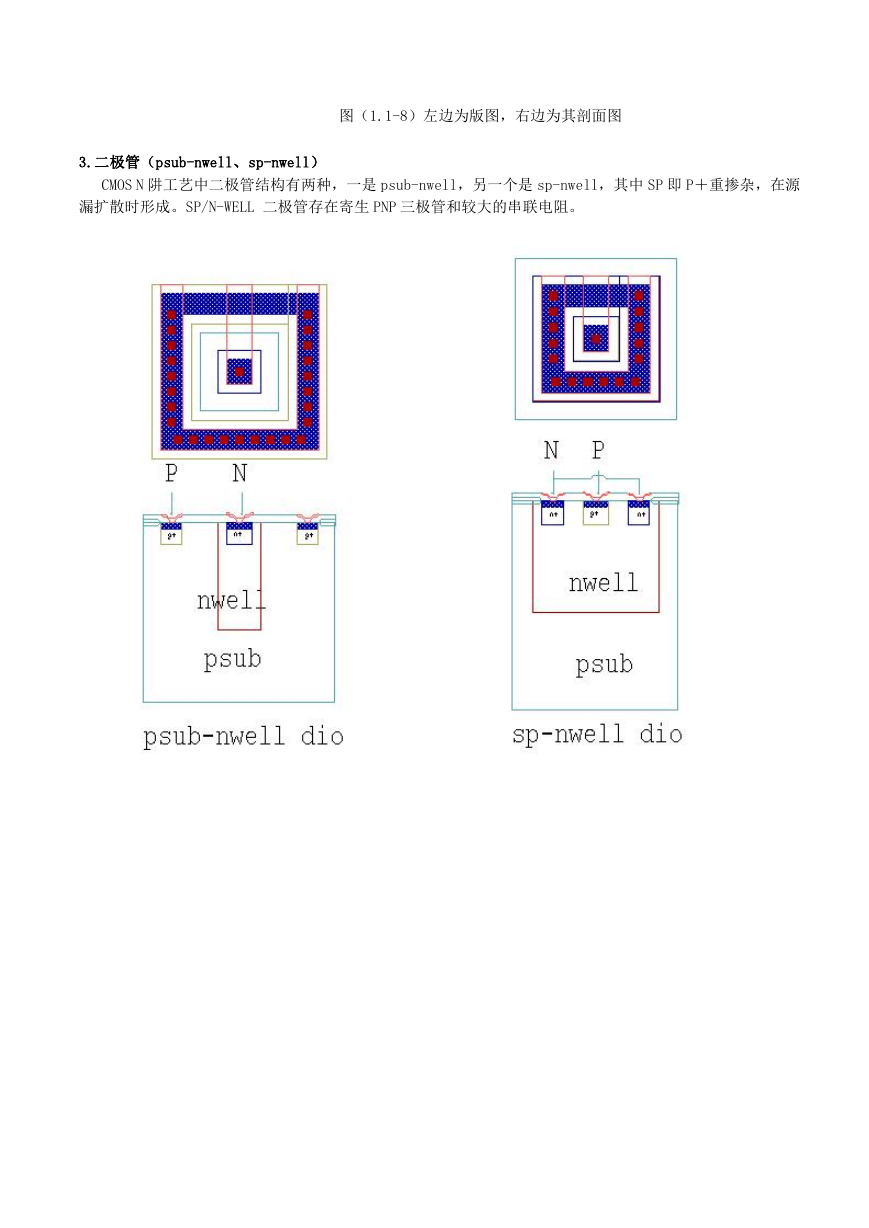
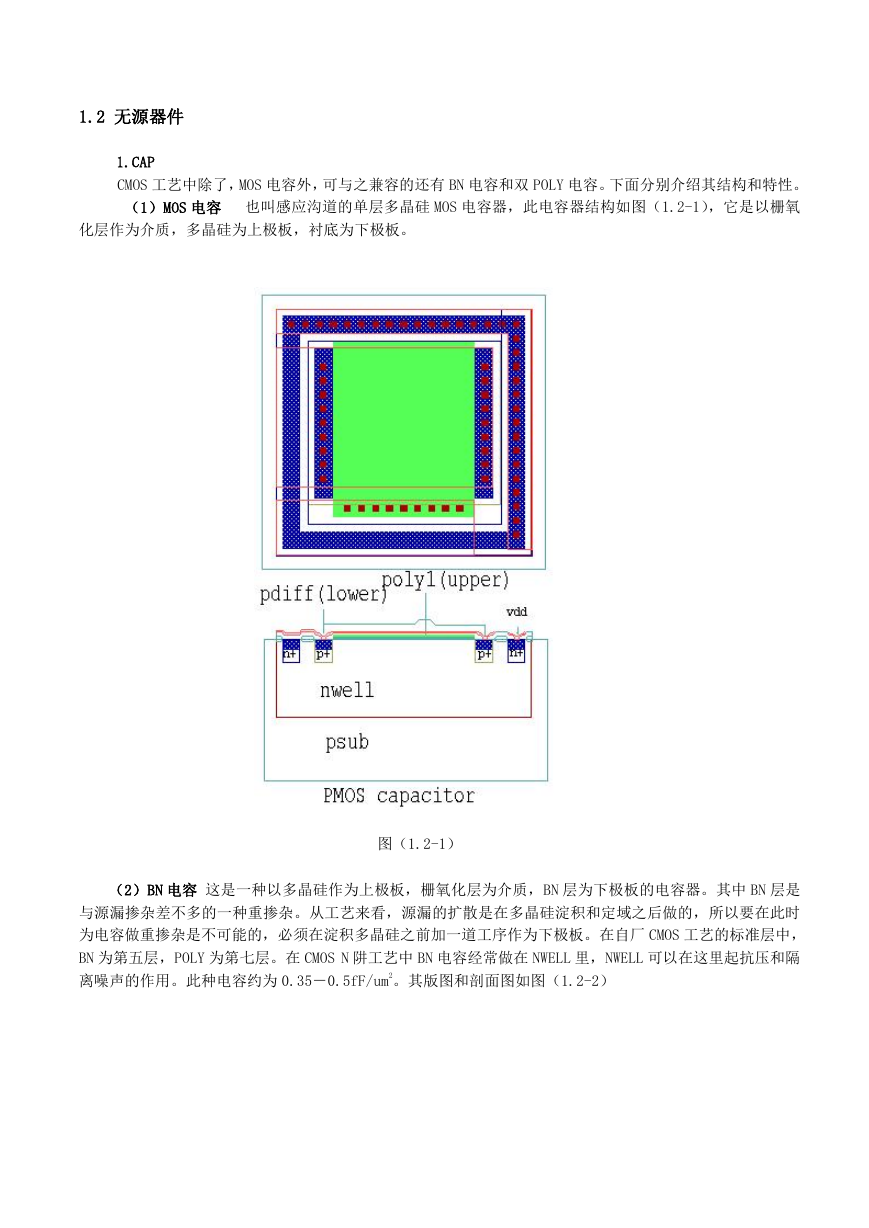
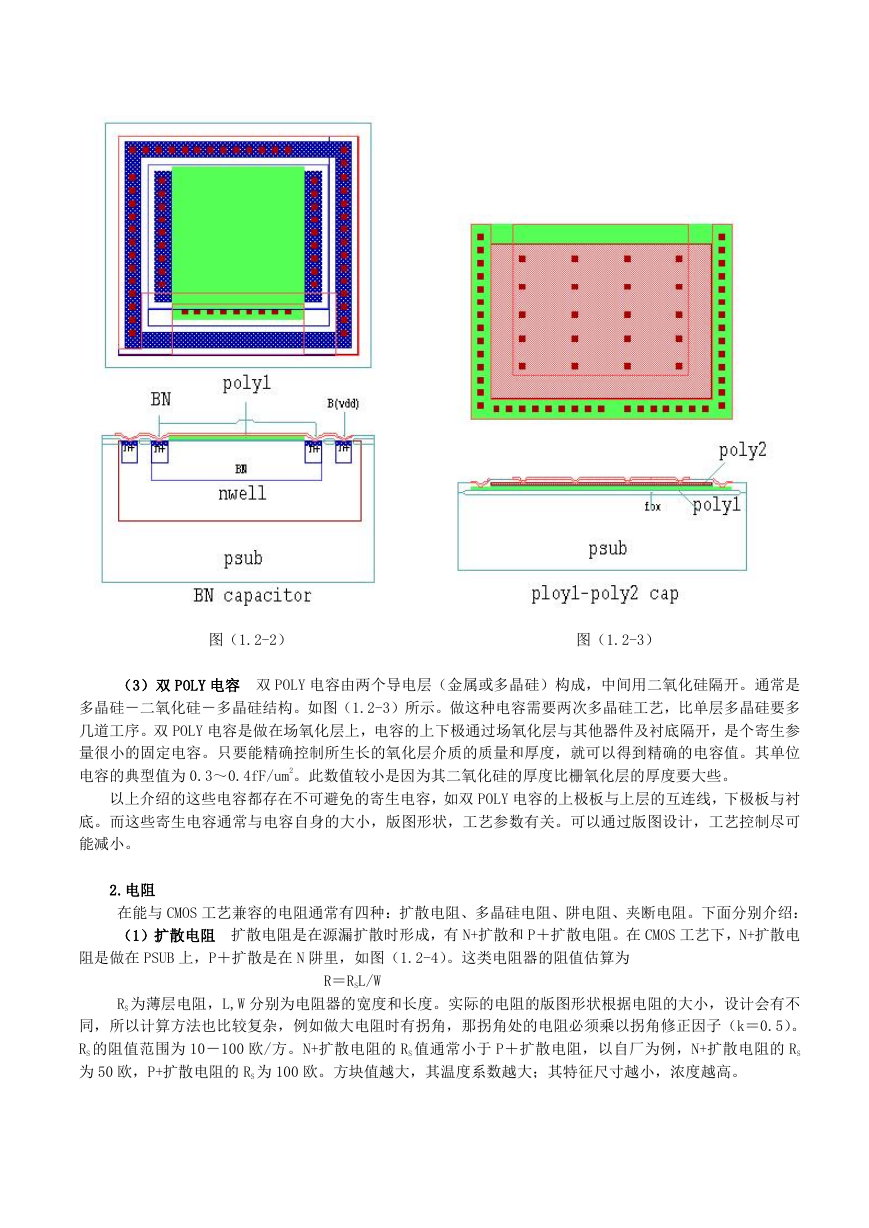
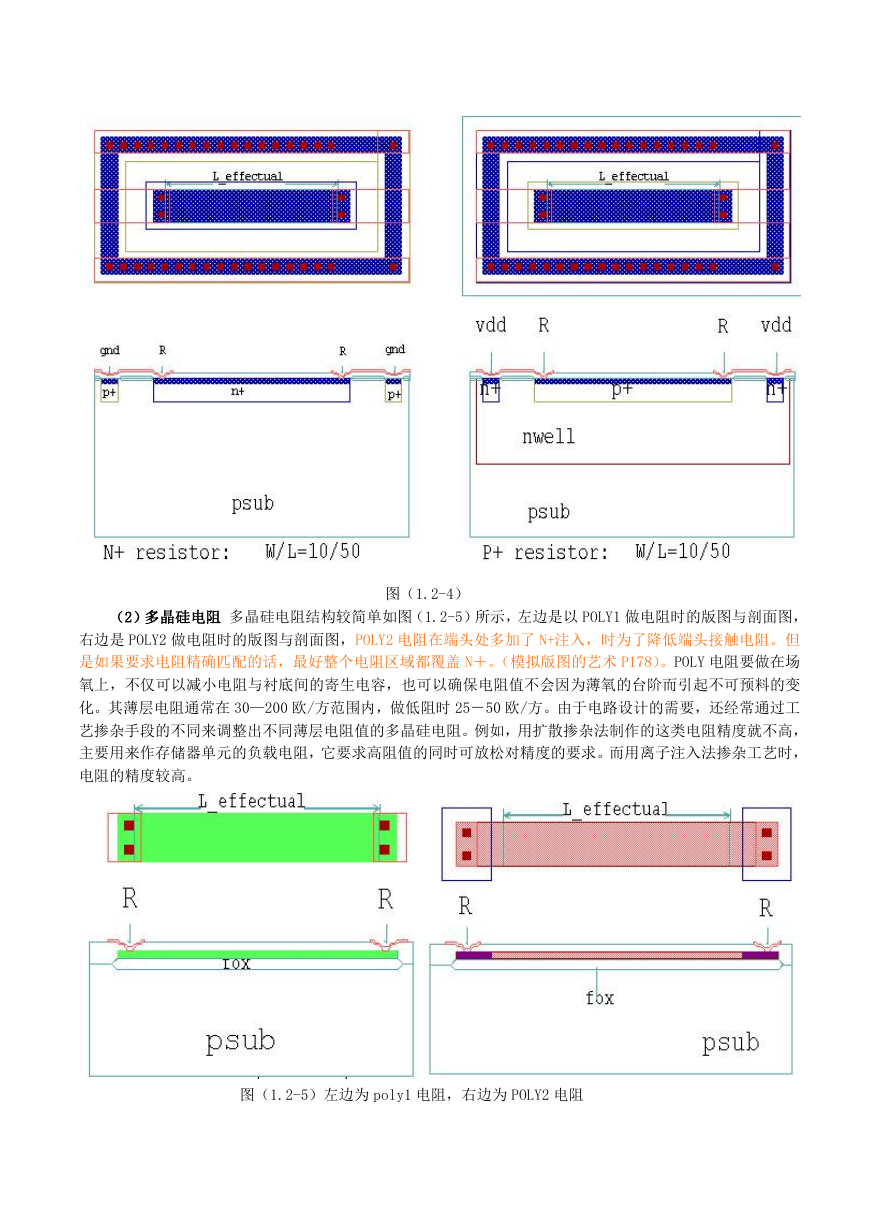
 2023年江西萍乡中考道德与法治真题及答案.doc
2023年江西萍乡中考道德与法治真题及答案.doc 2012年重庆南川中考生物真题及答案.doc
2012年重庆南川中考生物真题及答案.doc 2013年江西师范大学地理学综合及文艺理论基础考研真题.doc
2013年江西师范大学地理学综合及文艺理论基础考研真题.doc 2020年四川甘孜小升初语文真题及答案I卷.doc
2020年四川甘孜小升初语文真题及答案I卷.doc 2020年注册岩土工程师专业基础考试真题及答案.doc
2020年注册岩土工程师专业基础考试真题及答案.doc 2023-2024学年福建省厦门市九年级上学期数学月考试题及答案.doc
2023-2024学年福建省厦门市九年级上学期数学月考试题及答案.doc 2021-2022学年辽宁省沈阳市大东区九年级上学期语文期末试题及答案.doc
2021-2022学年辽宁省沈阳市大东区九年级上学期语文期末试题及答案.doc 2022-2023学年北京东城区初三第一学期物理期末试卷及答案.doc
2022-2023学年北京东城区初三第一学期物理期末试卷及答案.doc 2018上半年江西教师资格初中地理学科知识与教学能力真题及答案.doc
2018上半年江西教师资格初中地理学科知识与教学能力真题及答案.doc 2012年河北国家公务员申论考试真题及答案-省级.doc
2012年河北国家公务员申论考试真题及答案-省级.doc 2020-2021学年江苏省扬州市江都区邵樊片九年级上学期数学第一次质量检测试题及答案.doc
2020-2021学年江苏省扬州市江都区邵樊片九年级上学期数学第一次质量检测试题及答案.doc 2022下半年黑龙江教师资格证中学综合素质真题及答案.doc
2022下半年黑龙江教师资格证中学综合素质真题及答案.doc