5
10
15
20
25
30
35
40
中国科技论文在线
磁控溅射掺铝氧化锌薄膜的 Ar 气工艺条件
http://www.paper.edu.cn
研究#
宋瑞良1,2,刘玮1,孙云1**
(1. 南开大学光电子所,天津 300071;
2. 中国电子科技集团第 54 研究所,石家庄 050081)
摘要:磁控溅射掺铝氧化锌(AZO)透明导电膜是大面积太阳能薄膜电池工业化生产的重要
工艺手段。实验发现,在不同的 Ar 气进气方式的溅射过程中, AZO 薄膜都呈现了中间厚度
高于两侧厚度的不均匀现象,而且 Ar 气进气管的遮挡情况对厚度的峰值位置分布也有一定
影响。这是由于 Ar 气气流在靶表面的压强分布不均所导致的。本文通过实验和模拟的手段
分析了这种现象的机理,对提高溅射镀膜的均匀性起到理论指导作用。
关键词:磁控溅射;流体模型;氧化锌
中图分类号:TN305.92
Ar Air Technology Condition Research of AZO Thin Film
by Magnetron Sputtering Technology
SONG Ruiliang1,2, LIU Wei1, SUN Yun1
(1. Institute of Photo-electronic Thin Film Device and Technology, Nankai University,
2. The 54th Research Institute of China Electronics Technology Corporation,
TianJin 300071;
ShiJiaZhuang 050081)
Abstract: Magnetron sputtering Al-doped Zinc Oxide (AZO) thin film is the main method of large
area thin film solar cell fabrication in industry. In different sputtering conditions of Ar air flow
mode, the thickness of AZO thin films showed the obviously nonuniform phenomenon that the
thickness of thin film was larger in the middle than the side, the occlusion of Ar inlet could make
some influence on the position of thickness peak value. The reason was that the nonuniform
pressure distribution on the top of target could make the influence on the thickness of AZO thin
films. This paper analyzed this phenomenon by the means of experiment and simulation, that
would establish the theoretical foundation for the uniform thin films fabrication in large area
sputtering technology.
Keywords: Magnetron Sputtering; Fluid Model; Zinc Oxide
0 引言
磁控溅射是目前太阳能薄膜电池生产广为采用的薄膜沉积手段之一,也是最为成熟和稳
定的镀膜工艺[1-4]。磁控溅射包括辉光放电、离子溅射、原子或分子沉积等多个微观过程,
为了准确描述磁控放电,理论上多采用动力学模型[5-6],S.Kadlec 基于蒙特卡罗分析方法,
模拟等离子体中粒子的电离、碰撞、输运、等离子体壳层厚度与外加电压的关系[7]。在构建
磁场模型方面,一般采用有限元的模拟方法,通过改变靶的形状、极靴和永磁体尺寸进而改
善靶的磁路设计 [8-12]。对于等离子鞘层内粒子的输运过程,通常采用粒子模拟(Particle in
cell)和蒙特卡洛(Monte Carlo)相结合的 PIC-MCC 方法 [13-14],模拟包含碰撞模型的带电
粒子运动,计算离子在鞘层内的运动并考虑电荷交换碰撞及弹性散射 [15]。
但是,磁控溅射的工作气体 Ar 气,在磁控溅射过程中起着形成等离子体、调节靶材的
基金项目:高校博士点专项基金(200800551008)
作者简介:宋瑞良,(1980-),男,工程师,研究方向:化合物半导体器件和工艺。
通信联系人:刘玮,女,副教授,从事光伏薄膜材料及器件研究. E-mail: wwl@nankai.edu.cn
- 1 -
�
中国科技论文在线
http://www.paper.edu.cn
45
50
溅射产额、控制薄膜质量的重要作用。Ar 气的流量、Ar 气的进气口位置与溅射时带电粒子
的运动密切相关。在大规模连续镀膜的工业化生产中,如果进气管堵塞、老化导致溅射腔室
中的工作气流发生变化,必然会对溅射形成的薄膜造成影响。AZO 薄膜作为广泛应用于太
阳能薄膜电池的透明导电层材料,在大面积连续镀膜过程中的均匀性是影响太阳能电池光电
转换效率的重要因素之一。对于 AZO 薄膜溅射过程中的 Ar 气气流模型和影响薄膜均匀性
的机理,目前尚未见到有相关报导。因此,本文把溅射气体作为研究对象,对溅射过程中
Ar 气的流体场进行建模和研究,采用模拟和实验相结合的方法,通过有限元软件建立磁控
溅射的 Ar 气流体场分布,得到靶材表面、衬底表面、腔室空间气流的分布情况,进而获得
Ar 气气流影响 AZO 薄膜溅射厚度和电阻率的机理。
1 磁控溅射工艺的 Ar 气流体模型
本文采用 ANSYS 软件,对溅射腔室的 Ar 气流进行建模。模型采用流体单元选择
FLUID141,结构单元选择 PLANE42。
55
首先,通过测量 Ar 气进气口、靶宽度、衬底位置的距离,利用 ANSYS 的 FLOTRAN
模块建立该溅射腔室的二维模型,如下图所示。
图 1 流体模型示意图
Fig.1 Schematic diagram of fluid model
60
65
70
图 1 中,AZO 靶材宽 7cm,厚 5mm,衬底玻璃片一般放置在靶的正上方 5-6cm 处,Ar
气的进气管位于靶材两侧上方 1cm 处,气体的进气流量为 20sccm,腔室的本底真空是 1.5
×10-3Pa,溅射时工作气压是 0.4Pa,腔室的初始温度为 293K。
在溅射腔室中,Ar 气从进气口喷出后,气体吹向靶材表面。由于腔室空间小,气流在
靶材表面形成紊流。因此,在模拟流体特性选择时要根据紊流流体的特性进行设定和计算。
该模型中,做如下的载荷定义:
a. 设置左侧进气口和右侧进气口的位置以及流量(20sccm)
b. 设置靶材表面的垂直流速为 0
c. 设置腔室顶部的垂直流速为 0
d. 由于腔室的出气口在背面,而该模型为二维结构,因此近似将腔室的出气口设置
在底部。
当 Ar 气气流从进气管进入腔室时,通过流体模型得到腔室内部的 Ar 气气流矢量模拟
图如图 2 所示:
- 2 -
�
中国科技论文在线
http://www.paper.edu.cn
75
80
85
90
图 2 溅射腔室的气流矢量模拟分布图
Fig.2 Simulated distribution of Ar flow vector in sputtering chamber
2 磁控溅射工艺的 Ar 气流体实验研究
2.1 Ar 气气流溅射实验条件
溅射腔室的本底真空 2×10-3Pa,中频直流溅射脉冲频率 50kHz,占空比 8:12,Ar 气压
强 0.4Pa,Ar 流量 20sccm,溅射辉光时间 16min,溅射恒功率 150W,衬底玻璃片保持静止
以考察衬底片的 AZO 薄膜沉积情况。
在平面靶磁控溅射的过程中,两个进气管分列在平面靶两侧上方 1cm 处,如图 3(a)
所示。为了模拟在实际工艺生产中进气口因堵塞、故障等原因造成的左右进气管气流不对称,
设计了在遮挡进气口的情况下进行溅射,通过测量薄膜沉积的厚度以及电阻率考察气流对薄
膜质量的影响规律。
(a) 两侧进气管无遮挡
(a) With no occlusion (b) With occlusion on the right inlet
(b) 右侧进气管遮挡
(c) 左侧进气管遮挡
(c) With occlusion on the left inlet
图 3 靶材上方 Ar 气进气管示意图
Fig.3 Schematic diagram of Ar air inlet on the above of the target
- 3 -
�
中国科技论文在线
http://www.paper.edu.cn
95
实验 1:两侧 Ar 气进气管均无遮挡,如图 3(a)所示;
实验 2:对右侧的进气管进行遮挡,左侧无遮挡,如图 3(b)所示;
实验 3:对左侧的进气管进行遮挡,右侧无遮挡,如图 3(c)所示。
2.2 Ar 气气流溅射实验结果
根据上述三种实验条件,分别溅射出三种条件下的 AZO 薄膜,对三种情况下 AZO 薄
100
膜厚度和电阻率进行了测试。测试采用台阶仪和 Hall 测试仪。
在三种不同的遮挡进气口条件下,衬底片薄膜水平方向厚度分布如图 4 所示。从图上可
以看出,三种情况下薄膜的厚度都呈现了中间厚两侧薄的现象,说明在进气口有无遮挡的情
况下,薄膜的沉积速率在中间较高,两侧较低。对三种情况下的薄膜厚度进行平均化,发现
105
右侧遮挡、左侧遮挡、无遮挡的薄膜厚度平均值在无遮挡情况下最大,另外两种情况偏小。
这表明由于遮挡了进气口,薄膜的整体沉积速度有所下降。但是通过 Hall 测量,三种情况
下薄膜中心点的电阻率变化不是很大,但在无遮挡情况下电阻率稍低一些,其结果如图 5
所示。
110
115
图 4 三种遮挡情况下实测薄膜厚度分布曲线
Fig.4 Measured thickness of thin films in three occlusion ways
图 5 三种遮挡情况下实测薄膜平均厚度和电阻率分布曲线
Fig.5 Measured average thickness and resistivity of thin films in three occlusion ways
值得注意的是,在左侧遮挡或者右侧遮挡的情况下,虽然薄膜整体的厚度略有减薄,但
是对于左侧遮挡时,衬底片薄膜厚度最高值出现在中间偏左的位置,而右侧遮挡时,薄膜厚
度最高值出现在中间偏右的位置,在电场、磁场、功率、溅射时间等条件都没有变化的情况
下,确定是 Ar 的气流因素引起了薄膜厚度的变化。
- 4 -
�
中国科技论文在线
3 Ar 气气流对薄膜特性的影响分析
120
http://www.paper.edu.cn
根据上面的数据可以看出,对于不同的 Ar 气进气条件,AZO 薄膜的厚度和电阻率都呈
现了不均匀的现象。由于流体在接触到固体表面的时候,其流速和压强都会发生变化,导致
靶材表面形成不均匀的气流。由于溅射过程中,气流对靶材的压强决定了对靶材表面原子的
轰击速度,如果靶材的某个区域气体压强大,那么该区域的溅射速率就高,溅射产额变大,
125
所对应的衬底玻璃片的薄膜沉积速率更快,相同时间内薄膜沉积的厚度就更大。因此在实验
条件不变的情况下,可以通过模拟靶材表面的 Ar 压强来间接反映薄膜的溅射厚度。
图 6 两种遮挡情况下靶表面 Ar 气压强模拟分布图
Fig.6 Simulated Ar pressure distribution on the top of target in two occlusion condition
130
135
140
145
150
模拟 AZO 靶材表面的气压分布如图 6 所示。从模拟图上看,靶材表面的 Ar 气压强也
呈现了中间高两侧低的情况,不论左侧还是右侧进气管被遮挡,Ar 气压强都是在靶材中间
区域达到了最大值。当左侧或者右侧遮挡时,会引起压强最大值的位置出现在靶材中间偏左
或偏右的位置。这是由于进气管的垂直距离比靶材高 1cm,Ar 气从进气口喷射进来在重力
作用以及电磁场的作用下,离化成等离子体的形态分布到靶材表面,在进气口的位置、流速、
方向一定的条件下,汇集到靶材表面 Ar+气体压强产生了差异。从模拟结果看,可以较好的
符合实测的薄膜厚度分布。
4 结论
通过实验和模拟两种方法,对磁控溅射工艺的 Ar 气气流模型进行了研究,在不同的进
气管遮挡条件下,都呈现了靶材中央区域薄膜厚度高的现象,这是由于进气口的流速以及进
气口相对靶材角度大小的原因。通过对 AZO 溅射腔室的 Ar 气流的建模也分析了造成该现
象的原因。
[参考文献] (References)
[1] I.V. Svadkovski, D.A. Golosov, S.M. Zavatskiy, Characterisation parameters of unbalanced magnetron
sputtering systems [J], Vaccum, 2003, V68:283-290
[2] Durusoy H. Zafer, Duyar Ozlem, Aydinli Atilla, Influence of substrate temperature and bias voltage on the
optical transmittance of TiN films [J], Vaccum, 2003, V 70(122):21-28
[3] Hampshire J, Kelly P.J., Teer D. G., The structure of codeposited aluminium/titanium alloy coatings [J], Thin
Solid Films, 2004,418-424
[4] Bates R I, Arnell R. D., Microstructure of novel corrosion resistant coating for steel components by unbalanced
- 5 -
�
中国科技论文在线
http://www.paper.edu.cn
magnetron sputtering [J], Surface and Coatings Technology, 1977, V89:204-212
[5] White R. D., Ness K. F., Robson R.E., et al., Charged-particle transport in gases in electric and magnetic fields
crossed at arbitrary angles: Multitern solution of Boltzmann's equation [J], J. Phys. Rev.E, 1999, V60:2231-2249
[6] Ness K., Makabe T., Electron transport in argon in crossed electric and magnetic fields [J], J. Phys. Rev.E,
2000:4083-4090
[7] Kadlec, Computer simulation of magnetron sputtering - experience from the industry [J], Surface and coatings
technology, 2007: 895-903
[8] 谢国锋,王德武,应纯同,计及溅射损失的平行板静电场法离子引出和收集 [J],物理学报,2005,V54
(4):1543-1551
[9] 韩大凯,陈庆川,王经权,磁控溅射靶的磁路设计 [J],真空,2007,V44(6):14-17
[10] 邱清泉,励庆孚,苏静静,平面直流磁控溅射放电等离子体模拟研究进展 [J],真空科学与技术学报,
2007,V27(6):493-499
[11] 陈长琦,郭江涛,方应翠等,矩形平面磁控溅射阴极的磁场模拟及结构设计 [J],真空,2008 年,V45
(3):P65-89
[12] 赵华玉,牟宗信,贾莉等,平面磁控溅射靶磁场的计算 [J],真空科学与技术学报,2008 年,V28(3):
P271-274
[13] Birdsall C K., Particle-in-cell charged-particle simulations plus Monte Carlo collisions with neutral atoms [J].
PICMCC. IEEE Transactions on Plasma Science. 1991, V19(2):P65-85
[14] S. H. Lee, F. Iza, and J. K. Lee, Particle-in-cell Monte Carlo and fluid simulations of argon-oxygen
plasma:Comparisons with experiments and validations [J], Physics of Plasmas, 2006, V13:057102-1-9
[15] 吴丹,氩离子等离子体源离子注入的数值模拟[J],湖南文理学院学报,2008 年,V20(1):P35-38
155
160
165
170
- 6 -
�


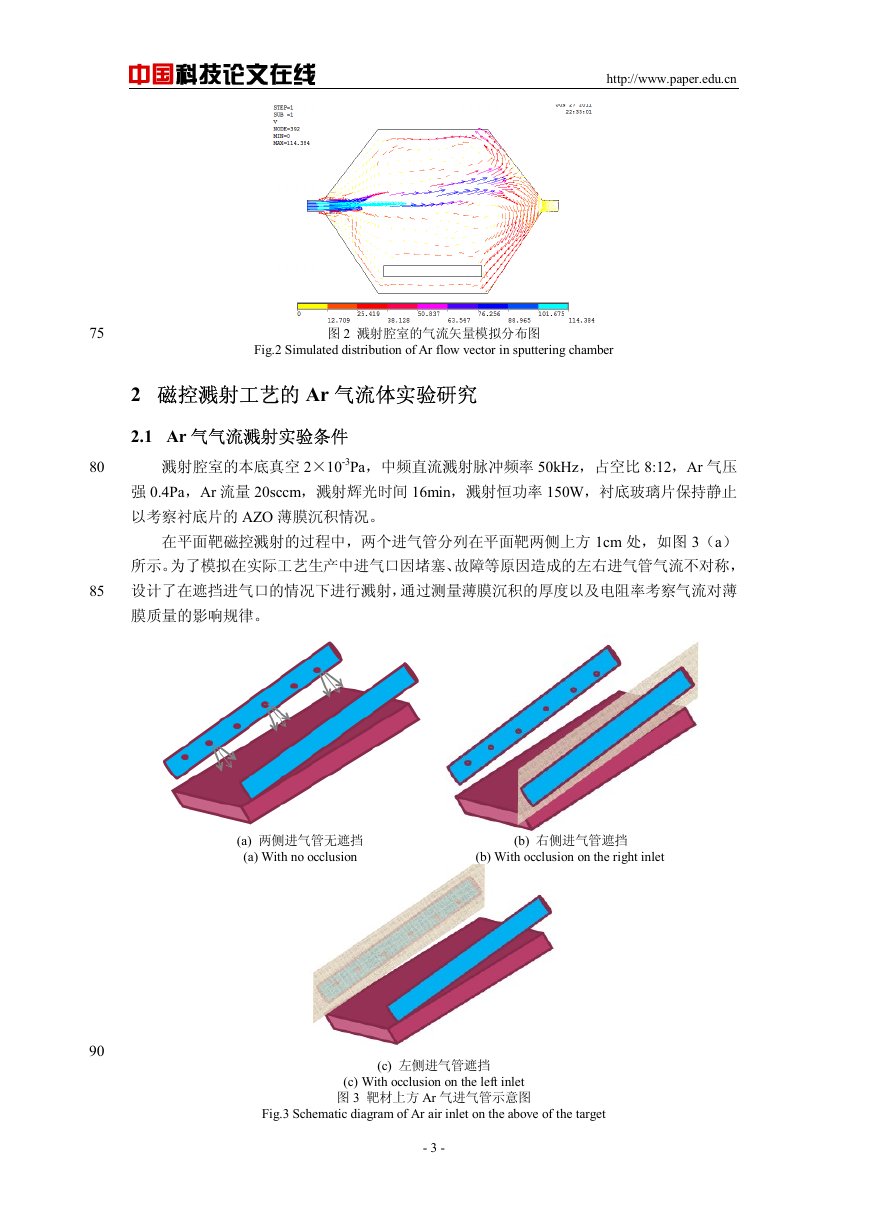





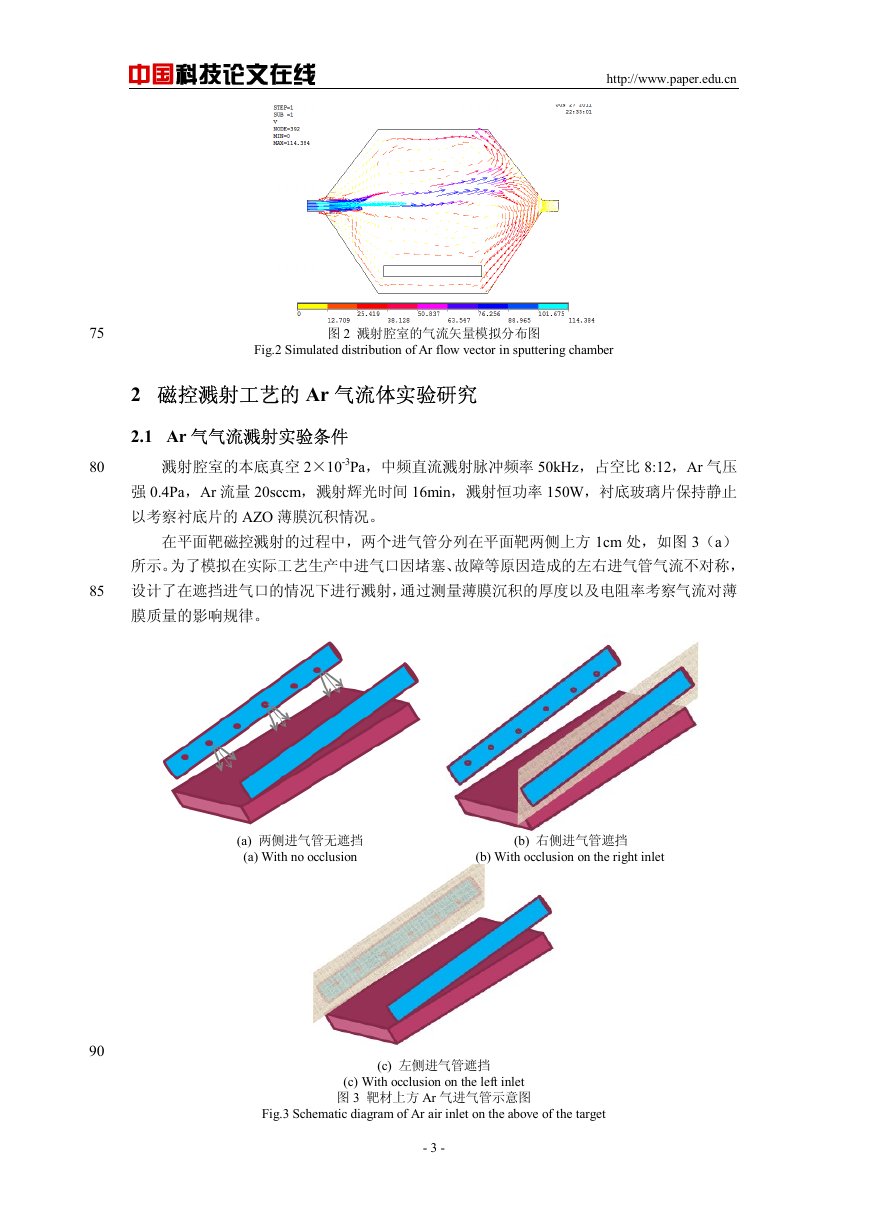



 2023年江西萍乡中考道德与法治真题及答案.doc
2023年江西萍乡中考道德与法治真题及答案.doc 2012年重庆南川中考生物真题及答案.doc
2012年重庆南川中考生物真题及答案.doc 2013年江西师范大学地理学综合及文艺理论基础考研真题.doc
2013年江西师范大学地理学综合及文艺理论基础考研真题.doc 2020年四川甘孜小升初语文真题及答案I卷.doc
2020年四川甘孜小升初语文真题及答案I卷.doc 2020年注册岩土工程师专业基础考试真题及答案.doc
2020年注册岩土工程师专业基础考试真题及答案.doc 2023-2024学年福建省厦门市九年级上学期数学月考试题及答案.doc
2023-2024学年福建省厦门市九年级上学期数学月考试题及答案.doc 2021-2022学年辽宁省沈阳市大东区九年级上学期语文期末试题及答案.doc
2021-2022学年辽宁省沈阳市大东区九年级上学期语文期末试题及答案.doc 2022-2023学年北京东城区初三第一学期物理期末试卷及答案.doc
2022-2023学年北京东城区初三第一学期物理期末试卷及答案.doc 2018上半年江西教师资格初中地理学科知识与教学能力真题及答案.doc
2018上半年江西教师资格初中地理学科知识与教学能力真题及答案.doc 2012年河北国家公务员申论考试真题及答案-省级.doc
2012年河北国家公务员申论考试真题及答案-省级.doc 2020-2021学年江苏省扬州市江都区邵樊片九年级上学期数学第一次质量检测试题及答案.doc
2020-2021学年江苏省扬州市江都区邵樊片九年级上学期数学第一次质量检测试题及答案.doc 2022下半年黑龙江教师资格证中学综合素质真题及答案.doc
2022下半年黑龙江教师资格证中学综合素质真题及答案.doc