第37卷 第1期
2017年1月
光 学 学 报
ACTAOPTICASINICA
Vol.37,No.1
January,2017
调平聚焦伺服控制系统的优化设计
宗永红1,2,周常河1,麻健勇1,王 津1,2,卢炎聪1,2
1中国科学院上海光学精密机械研究所信息光学与光电技术实验室,上海201800;
2中国科学院大学,北京100049
摘要 以提高共焦差动并行激光直写中光束刻写质量为目标,分析设计了调平 聚 焦 伺 服 控 制 系 统.采 用 柱 面 镜 作
为像散元件,与四象限光电探测器结合,利用差动像散检测方法和比例积分微分(PID)反馈算法 减 少 光 源 和 外 部 干
扰的误差,获得高灵敏度、高精度、高稳定性的探测 曲 线.通 过 优 化 光 学 设 计 参 数,本 系 统 能 获 得 具 有 高 灵 敏 性 与
一致稳定性的探测曲线,探测范围为3μm,静态聚焦误差 可 达 ±5.0nm;动 态 聚 焦 压 电 陶 瓷(PZT)伸 长 量 可 保 证
在焦深范围内,焦点位置辨别精度可达纳米量级,可探测调平台的倾斜角和俯仰角在0.01mrad左右.利用该 系 统
可实现光栅的刻写,进一步为更大尺寸、更高密度的光栅刻写提供依据.
关键词 测量;光栅;调平调焦;参数优化;差动像散;反馈控制
中图分类号 O436 文献标识码 A
doi:10.3788/AOS201737.0122001
OptimizedDesignofLevelingandFocusingServoControlSystem
ZongYonghong1 2 ZhouChanghe1 MaJianyong1 WangJin1 2 LuYancong1 2
1LaboratoryofInformationOpticsandOptoelectronicsTechnology ShanghaiInstituteofOpticsandFineMechanics
ChineseAcademyofSciences Shanghai201800 China
2UniversityofChineseAcademyofSciences Beijing100049 China
Abstract Alevelingandfocusingservocontrolsystemisbuilttoimprovethefocusaccuracyofthedifferential
parallelconfocallaserdirectwritingsystem敭Toobtainadetectioncurvewithhighsensitivity accuracyandstability
thecylindricallensasanastigmatism elementiscombinedwithfourGquadrantphotodetector andthedifferential
astigmatismdetectionmethodandproportionintegrationdifferentiation PID feedbackalgorithmsareemployedto
reduceerrorscausedbylightsourceandexternalinterference敭Byoptimizingtheopticalparameters thedetection
curvewithhighsensitivityandstabilityhasbeenobtained witharangeofaround3μmandastaticfocusingerrorof
±5敭0nm敭Thestretchingofpiezoelectricceramictransducer PZT canbeguaranteedwithinthedepthoffocus
rangeinthedynamicmode敭NanoGscaleprecisionofthefocalpositioncanbeachieved andthetiltandpitchoflever
adjusterapproximate0敭01 mrad敭Utilizingthissystem gratingscanbefabricated andthissystem canprovide
referenceforthefabricationoflargerGsizeandhigherGdensitygratingsinthefuture敭
Key words measurement grating leveling andfocusing parameteroptimization differentialastigmatism
feedbackcontrol
OCIScodes 050敭2770 080敭1010 090敭1000 150敭5495
1 引 言
激光直写技术是一种无需掩模的新型光刻技术[1G3],该技术以其低成本、低要求、多功能等优势一直被广
泛应用于加工掩模、衍射光学器件[4G5]等不同的领域.但是,在刻写过程中,尤其是在大面积、高密度光栅掩
模的刻写过程中,如何提高刻写精度,保证线条的均匀与线条的刻写质量是一个难题.由于刻写的光栅尺寸
大,精度要求高,因此,必须设计灵敏度高、一致性好的调平聚焦伺服控制系统.聚焦伺服控制系统的核心是
收稿日期:2016G07G15;收到修改稿日期:2016G09G06
基金项目:国家科技部项目(2012YQ170004)、国家自然科学基金(61307064)
作者简介:宗永红(1991—),女,硕士研究生,主要从事光栅制造方面的研究.EGmail:zongyongh16@163.com
导师简介:周常河(1965—),男,研究员,博士生导师,主要从事光栅制造与衍射光学理论、测量等方面的研究.
EGmail:chazhou@mail.shcnc.ac.cn(通信联系人)
0122001G1
�
光 学 学 报
焦点检测技术[6G7].目前聚焦控制系统中的自动调焦方法有多种,包括临界角法[8]、针孔法[9]、像散法等.像
散法作为一种常见的调焦手段,其光学系统简单,测量灵敏度高,损失光能少,便于实时地实现对被测物体微
位移变化的精确测量[10G13].
目前国内外关于利用差动像散法进行离焦检测技术的研究比较广泛,其中哈尔滨工业大学利用此技术
设计出了差动像散离焦检测实验装置[14]和基于单向离焦的差动像散检测实验装置[15].但是对于大面积衍
射光栅[16G17]的刻写,由于在平台移动过程中,平台的倾斜度对实验影响较大,并且原有的差动像散装置不足
以满足大尺寸高精度光栅的刻写要求,故本文的实验装置在差动像散检测原理的基础上,加入调平模块,进
行了光路设计,调平模块可以根据四象限光电探测器 上 基 片 反 射 光 的 位 置,推 断 出 基 片 台 的 倾 斜 角 和 俯 仰
角,避免了刻写过程中出现的离焦现象.
本文以提高大面积光栅的刻写线条质量、提高像散曲线灵敏度与聚焦位置的辨识精度为目标,分析设计
了调平聚焦伺服控制系统[18G19].该系统不仅保留了传统像散法检测技术灵敏度高、易于实现的优点,同时克
服了光源和周围环境随机波动对调焦系统带来的干扰,从而保证了整个系统在长时间的刻写过程中始终能
将调焦镜头锁定在焦深范围内.该系统可用于多光束激光直写装置[20]来刻写大面积光栅,实验表明本系统
装置能获得良好的稳定性与灵敏度探测曲线,测量精度可达到纳米量级.
2 像散法
2.1 像散法基本原理
光学像散法的基本原理图如图1所示:其中,f1 为物镜的焦距;r1 为物镜的口径半径;f2 为柱面镜的焦
距;r2 为柱面镜的口径半径;n为柱面镜与四象限光电探测器(PSD)之间的距离;l1 代表物镜与柱面镜之间
的距离;a为物镜与被测物体表面之间的距离;m 为柱面镜的像距,l2 为物镜的像距,b为柱面镜的物距.
图1 单个像散基本原理图
Fig敭1 Basicschematicdiagramofsingleastigmatic
假设S1、S2、S3、S4 分别为光电探测器第一、二、三、四象限输出的光强信号,则离焦误差 信 号(FES)如
下式[15]所示:
(1)
FES =
)
(
) - S2 +S4
S1 +S3
(
S1 +S2 +S3 +S4 ,
πarcsin ry
æ
ç
è
ö
÷
ø
假设C2 为光电转换系数,则单个像散输出的FES为[14]:
ù
ú ,
ú
û
FES =C2 1-4
é
ê
ê
ë
r2x +r2y
(2)
式中rx 和ry 分别为四象限光电探测器上椭圆光斑的长轴和短轴,将光学参数f1、f2、n、l1 代入(2)式,利用
Matlab软件仿真可得到不同光学参数下FES随离焦量(X)的变化关系,如图2所示.
由图2可知,在零点附近,FES和X 大体呈线性关系,并且光学参数不同时,曲线的灵敏度不同.因此
根据像散法原理可知,在以零点为中心的一段对称的线性区域内,可以根据FES 的大小来得到被测物的离
焦量X 的大小和方向.
2.2 差动像散法
在像散法的基础上,分别利用2个柱面镜和2个四象限光电探测器,并将探测器分别位于柱面镜的焦前
0122001G2
�
光 学 学 报
图2 不同光学参数下,离焦误差随X 变化曲线
Fig敭2 DefocuserrorversusXunderdifferentopticalparameters
与焦后相同的位置处,构成差动像散检测,在像散法理论的基础上,可以得到差动像散法的FES.
根据激光束光学建立的差动像散法检测系统数学模型如下,首先,将差动像散光路中的一路光路展开,
如图3所示.图3中,f1 为物镜的焦距,f2 为柱面镜的焦距,X 为离焦量,l1 为聚焦物镜与柱面镜之间的距
离,l2 为柱面镜与探测器之间的距离.
图3 单光路展开示意图
Fig敭3 Schematicdiagramofsingleopticalpath
[
(
qx = -f21 -2Xf1 -l1 -l2
qy= f2 -l2
(
设探测器面上x、y方向的复曲率半径分别为qx、qy,根据 ABCD 定则,可得:
) f1 -l1 -l2
(
) +2l2f2X
) -f1f2l2(f1 +2X)}/
) -f1(f2 -l1)(f1 +2X)
] ×q0 +2f1 f1 +X(
2X×q0 -2Xf21 -f21
) 2l1X-2Xf1 -f21
(
(
[
{
) 2f21 +2Xf1 -2l1X-l1f1
q0 +f1 f2 -l2
(
f21 +2Xf1 +2Xf2 -l1
] ×q0 -2f21 f1 +X(
[
(
] ×
) +(l1 +l2)f21
} ,
{
)
)
式中q0 为入射到物镜上的高斯光束的复曲率半径.推导出探测器上的光斑在x、y方向上的半径分别为
,
(3)
(4)
(5)
ì
ωx = - λ
ï
ïï
í
ï
ωy= - λ
ïï
î
πIm(1/qx)
,
πIm(1/qy)
探测器 A、B 到柱面镜的距离分别为l11、l12,综合(3)~(5)式,可得到探测器 A、B 上的光斑半径分别为
式中Im()表示虚部.
ωAx、ωAy 和ωBx、ωBy. 则差动像散法检测的FES为
π arctanωAx
æ
ç
ωAy
è
FES =4
é
êê
ë
ö
ø
÷ -arctanωBx
æ
ç
ωBy
è
(6)
由上述可知,FES由两个探测器上的光斑半径之比决定,且FES和X 的关系主要取决于光学系统参数
的选择[21]:聚焦物镜和柱面镜的焦距(f1、f2)、聚焦物镜与柱面镜的距离(l)、柱面镜和两个探测器之间的距
离(l11、l12),探测器到柱面镜焦平面的距离(m).根据上述分析,利用 Matlab软件仿真,分别得到FES与X
之间的对应关系曲线如图4所示.
由图4可知,利用差动离焦像散检测时,系统的灵敏度与f1、f2、l和m 有不同的关系:
ù
úú .
û
ö
÷
ø
0122001G3
�
光 学 学 报
图4 FES与X 之间的对应关系曲线.(a)不同光学参数时的误差曲线;(b)f1=5.00mm,f2=350mm,
l=400mm,m=80mm 时的误差曲线
Fig敭4 CorrespondingrelationshipcurvesbetweenFESandX敭 a Errorcurvewithdifferentopticalparameters
1)系统灵敏度与f1、m 成负相关,与l、f2 成正相关,f2 越大,灵敏度越高,但相应的测量范围会变小;
2)f1 与f2 对系统灵敏度的影响程度要大于其他参数对系统灵敏度的影响.
b errorcurvewithf1=5敭00mm f2=350mm l=400mm m=80mm
3 系统光路设计
由上述分析可知,FES和X 的关系主要取决于光学系统参数的选择.根据系统测量范围小,系统灵敏
度高和探测曲线一致性好等一系列要求,根据图4,再结合实际光学元件制造工艺要求,确定了一套光学参
数,分别为:f1=2.00mm,f2=300mm,l=400mm,l11=380mm,l12=220mm.搭建系统结构如图5所
示.本系统中包括红光调平 和 自 动 聚 焦 模 块,系 统 采 用 的 是 平 场 复 消 色 差 短 焦 镜 头,共 轭 距 离 为 无 穷 远,
675nm的平行光束会聚在样品的光敏感层上,经其反射后,由分束镜分为两束光,反射的光 构 成 调 平 模 块,
根据传感器上光斑的分布情 况 可 以 确 定 样 品 台 的 倾 斜 和 俯 仰 的 程 度.假 定 传 感 器 的 探 测 精 度 在5μm 以
内,如果传感器距离干涉成像面的距离为500mm,对应的可探测调平台的倾斜和俯仰在0.01mrad左右,样
图5 光路示意图
Fig敭5 Schematicofopticalsystem
0122001G4
�
光 学 学 报
品在300mm×300mm 的移动范围内,最大倾斜和俯仰在3μm 左右,可以在整个样品范围内成功地实现自
动聚焦.透射的红光被均分为两路,分别经过柱面镜到达传感器(四象限光电探测器)表面,构成自动聚焦模
块.本系统结构分别采用差动和单向像散测量法时的FES和X 的关系如图6所示.由图6可知,单向像散
测量法X 的变化范围为-5~3μm,FES在-0.8~1之间,而利用差动像散检测法时,X 在-1~1μm 之间
变化,FES可在-0.3~0.7之间变化,相比于单向测量法,差动测量法X 的变化范围更小,曲线平滑性更好,
灵敏度与一致性更好.
图6 FES与X 仿真曲线
Fig敭6 SimulationcurvesofFESandX
4 控制实现
本系统可分为调平和调焦两个独立模块,聚焦执行器件为压电陶瓷(PZT),其行程能达到400μm,并且
扫描和定位分辨率高,可达到亚纳米量级,响应速度快,线性度非常好.镜头安装在PZT 上,整个自动聚焦
模块安装在稳定性极高的支架上,避免由于样品移动带来的振动.在电压驱动 下,PZT 可 带 动 长 镜 头 沿Z
向以纳米级精度运动.
调平模块主要是依据CCD 上二维点阵的清晰程度来手动操作完成的,是为调焦模块做准备的,其目的
是增加调焦的准确性和提高调焦的效率,一旦完成调平模块进入调焦模块后,调平模块就不再运行.
首先进行调平模块,为了实现快速调平,如图5所示,采用二维达曼光栅,由转接透镜组将其转接成像于
短焦镜头的入瞳位置,通过短焦镜头聚焦于样品的表面,并在其上形成二维的点阵分布,反射光经过宽带偏
振分光镜最终共焦成像于CCD 的表面,只有当样品台位于刻写光路短焦镜头的焦平面位置时,反射光才能
在大光敏面的CCD 上成清晰的像,因此可以通过CCD 上二维点阵的清晰程度快速判断样品台是否已经被
调整到位.当二维点阵少数点清晰时,此时调平没有达到要求,手动调节平台,直到二维点阵绝大多数点清
晰时,才能确定已经大致调节到位.采用调平模块避免了在大尺寸光栅刻写过程中出现离焦现象,提高了最
终刻写光栅线条的均匀性;并且加入调平模块后,避免了PZT 的Z 向伸长量的大范围变化,缩短了PZT 的
响应时间,从而提高了平台移动速度,进一步缩短了光栅刻写所需的时间,提高了效率.调平达到要求后运
行调焦模块,在调焦模块中进行实时离焦检测从而实现实时聚焦.
自动聚焦系统是聚焦光斑能否始终锁定在显微物镜焦平面的关键,直接影响最终条纹的质量.系统中
含有 许 多 任 务:参 数 配 置、事 件 触 发、状 态 执 行. 为 使 系 统 正 常 运 行,不 同 任 务 间 不 相 互 干 扰,利 用
LabVIEW 软件实现对各个任务的控制,控制流程如图7所示.
本系统中触发事件为:外界激光范围值改变、目标FES和比例积分微分(PID)参数值改变、开始扫描事
件、停止扫描(开始自动聚焦)事件、前面板关闭事件和stop事件.
本系统的状态有:初始化状态、扫描状态、自动聚焦状态、离焦状态.系统上电后默认为初始化,后执行
扫描状态,在没有外界事件触发时,一直处于该状态;当停止扫描(开始自动聚焦)事件触发时,系统进入自动
聚焦状态,刻写运动平台运动,此时状态称为动态状态,产生的误差称为动态误差,该误差与平台移动速度、
PZT 分辨率、PID 参数等因素有关,当误差达到一定数值时进入离焦状态,系统停止运行.
自动聚焦模块采用PID 算法进行实时反馈控制,其原理如图8所示.在刻写过程中,由于平台震动、外
0122001G5
�
光 学 学 报
图7 系统控制流程图
Fig敭7 Controlflowchartofthesystem
界环境等因素的影响,相对于基准位置可能产生一定的离焦,通过LabVIEW 软件编程得到相应的离焦误差
量,将该离焦误差量作为PID 反馈算法的输入,得到PZT 的Z轴的新位置,输出驱动电压,驱动PZT 进行Z
向移动到新位置,达到基准位置.由于PZT 的响应速度快,能精确调焦,根据PID 控制计算结果,改变PZT
的伸长量,循环反馈实现实时聚焦和对刻写线条的实时锁定,直至系统停止.
5 实验结果
由上述分析可知,实验辨别精度主要取决于探测曲线在零点附近的线性区域的灵敏度与稳定性,为此,
进行实验验证,得到不同情 况 下 的 曲 线 来 评 估 系 统 的 优 越 性. 在 已 搭 建 的 单 向 像 散 聚 焦 的 实 验 平 台 基 础
上[22],根据图5搭建本系统实验平台,利用LabVIEW 软件编程实现伺服聚焦系统的人机交互.
当气浮平台以60mm/s的速度运动进行刻写时,本系统(差动)实验过程测得的控制软件人机交互界面
(动态)如图9所示,原来的实验系统(单向)的实验FES曲线如图10所示.而当气浮平台没有运动时,利用
本系统测得的控制软件人机交互界面(静态)如图11所示.
由于光电探测器的安装与原系统(理论计算)采用的探测器象限位置相反,故图9左下角离焦曲线与原
系统实验FES 曲线(图10)形状不同,但其本质是一样的.
在图9、图11的人机交互界面,左上角窗口红色线表示探测器接收到的反射红光能量在Z 向扫描范围
内的大小;左边中间窗口为实时显示的FES曲线,横坐标表示压电陶瓷PZTZ 向扫描的扫描行程,单位为
0122001G6
�
光 学 学 报
图8 自动聚焦模块PID 控制算法原理图
Fig敭8 PrinciplediagramofPIDcontrolalgorithminautomaticfocusingmodule
图9 系统动态自动聚焦模块界面
Fig敭9 Interfaceofsystemdynamicautofocusmodule
μm,这里采用的PZT 可以在0~400μm 范围内连续扫描;右边中间为目标FES大小以及实际FES实时大
小变化;右下角窗口为聚焦PZT 的实时伸长量(单位为μm).工作过程为:根据实验需求与误差校正量设定
好目标FES大小,设置合适的PID 控制参数值,然后点击自动聚焦按钮进行自动聚焦工作.另外在刻写过
程中可以随时直接调整目标FES大小值来控制刻写焦点的位置,不需要中断刻写过程,这一特点在刻写具
有不同特征线宽的同一个图形时非常重要.
0122001G7
�
光 学 学 报
图10 原系统实验结果
Fig敭10 Experimentalresultofinitialsystem
图11 系统静态自动聚焦模块界面
Fig敭11 Interfaceofsystemstaticautofocusmodule
由图9左边中间FES曲线可知:FES在-0.6~0.4之间,并且曲线有很好的线性度,线性范围窄,线性
量程为3μm 左右,利用高精度激光干涉仪作为测量仪器,实验可得聚焦误差(动态误差)约为30.0nm,与理
论结果(图6)基本相 符. 而 在 图10 中,原 实 验 探 测 曲 线 的 FES 可 在-0.7~0.7 之 间,其 探 测 范 围 约 为
4.8μm,聚焦误差可达34.3nm.相比于原单向系统,本系统精度得到了一定的提高,引入的差动可以减小
光源由于长时间工作带来的误差,并且本系统额外引入调平光路,可推断出基片台的倾斜角和俯仰角并保证
整个基片在刻写范围内样品的倾斜和俯仰在一定范围内.
系统动态工作(图9)时,FES在0.1左右时具有良好的线性段,刻写时目标FES为0.1,实时得到的FES
以0.1为中心上下摆动,波动范围约为0.05~0.15;在焦深范围内PZT 的实时伸长量也相对较大,伸长范围
约 为300nm,开始最大可达400nm.而静态工作时,由图11可知,FES在0.2左右时具有良好的线性段,实
时FES围绕0.2的波动非常小,基本保持在0.2;但由于平台震动、周围环境等因素的影响,实际PZT 实时伸
长量有一定的变化,其变化范围非常小,约为10nm.相比于 静 态 工 作,动 态 工 作 的 误 差 较 大,PZT 在 焦 深
范围内的变化范围也比较大,这与气浮平台的运动速度和PID 参数等因素有很大的 关 系.一 方 面,在 一 定
速度范围内,气浮平台运动速度越大,平台震动会越严重,导致动态误差越大,并且由于刚开始运动时,平台
不稳、震动相对严重等因素使开始时得到的实时FES变化比较大;另一方面,PID 反馈算法及参数的选择对
误差也有一定的影响.PZT 可视为一个二阶振荡环节,控制算法、参数选择等因素会对系统上升时间、超调
0122001G8
�



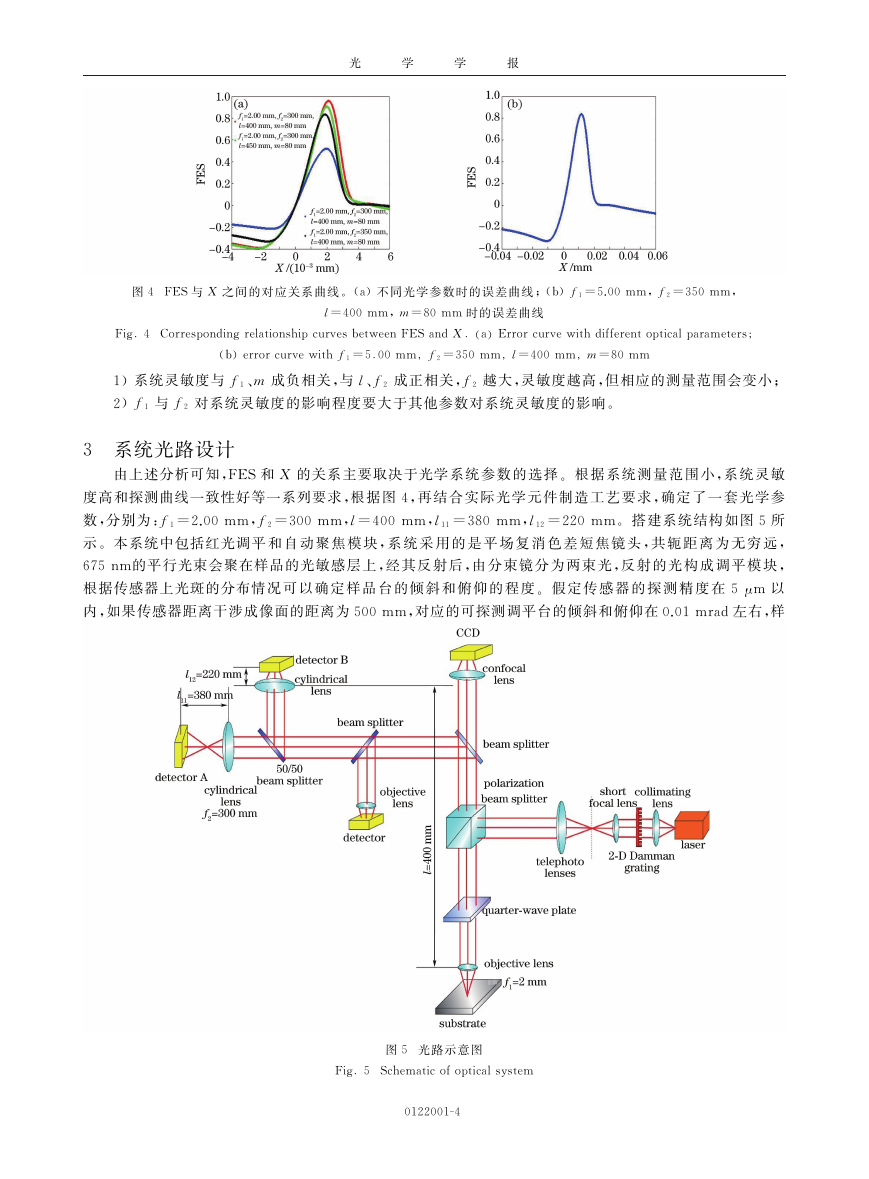







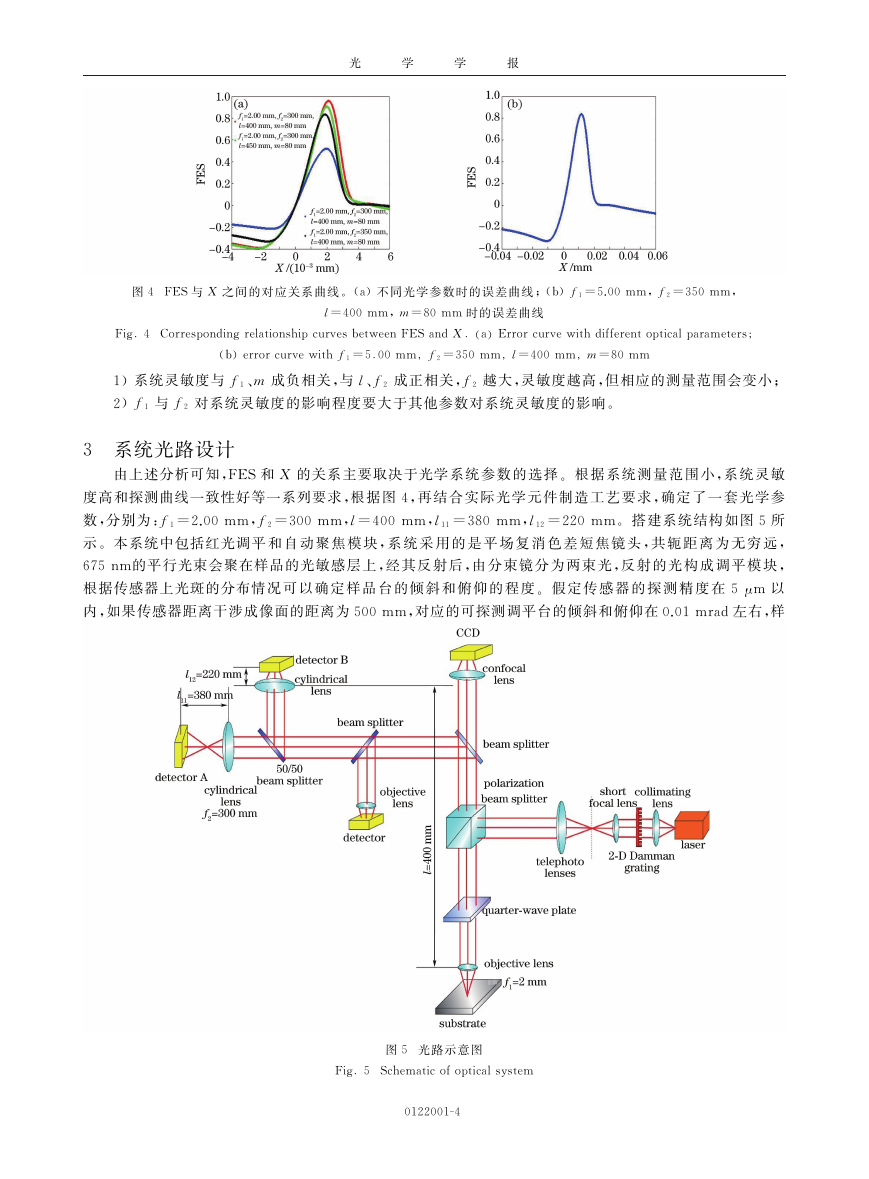




 2023年江西萍乡中考道德与法治真题及答案.doc
2023年江西萍乡中考道德与法治真题及答案.doc 2012年重庆南川中考生物真题及答案.doc
2012年重庆南川中考生物真题及答案.doc 2013年江西师范大学地理学综合及文艺理论基础考研真题.doc
2013年江西师范大学地理学综合及文艺理论基础考研真题.doc 2020年四川甘孜小升初语文真题及答案I卷.doc
2020年四川甘孜小升初语文真题及答案I卷.doc 2020年注册岩土工程师专业基础考试真题及答案.doc
2020年注册岩土工程师专业基础考试真题及答案.doc 2023-2024学年福建省厦门市九年级上学期数学月考试题及答案.doc
2023-2024学年福建省厦门市九年级上学期数学月考试题及答案.doc 2021-2022学年辽宁省沈阳市大东区九年级上学期语文期末试题及答案.doc
2021-2022学年辽宁省沈阳市大东区九年级上学期语文期末试题及答案.doc 2022-2023学年北京东城区初三第一学期物理期末试卷及答案.doc
2022-2023学年北京东城区初三第一学期物理期末试卷及答案.doc 2018上半年江西教师资格初中地理学科知识与教学能力真题及答案.doc
2018上半年江西教师资格初中地理学科知识与教学能力真题及答案.doc 2012年河北国家公务员申论考试真题及答案-省级.doc
2012年河北国家公务员申论考试真题及答案-省级.doc 2020-2021学年江苏省扬州市江都区邵樊片九年级上学期数学第一次质量检测试题及答案.doc
2020-2021学年江苏省扬州市江都区邵樊片九年级上学期数学第一次质量检测试题及答案.doc 2022下半年黑龙江教师资格证中学综合素质真题及答案.doc
2022下半年黑龙江教师资格证中学综合素质真题及答案.doc