总体仿真流程概括:
SPROCESS 模拟工艺步骤,比如光刻、离子注入、退火等,进而得到一个含
有材料、边界、掺杂信息的文件
SDE 读取 SPROCESS 的输出文件,利用图形化界面打开,再对结构添加电
极、划分网格,然后输出一个含有电极信息并划分好网格的文件
实际上 SDE 可用来手动绘制想要的器件结构,包括材料、边界、掺杂等。
Sdevice 读取经过 SDE 处理的输出文件,并利用各种物理模型与数学算法,
模拟器件的各种物理参数。
下面以一个完整的流程为例,分部分说明
SPROCESS
操作流程:
1. 新建工程:Project——new——new project (左上角)
2. 添加仿真工具:在“No Tools”面板上右击“add„”添加仿真工具 sprocess
然后选择“Use Ligament to Create Input Files”-“yes”
�
3. 右键点选选择新加的 sprocess 图标,选择 Edit Input——Ligament Flow,得到新的
Ligament Flow Editor 界面。点击 Edit——Add Process Header,得到工艺仿真的头文件。
点选 environment,在参数显示区修改:(双击)
◆ title 自定义名字
◆ region 修改为 0 0 5.1 2
注:
x0,y0
X
Y
x1,y1
仿真区域是以(x0 y0 x1 y1)的顺序表示的。但是其对深度的设定,即 y0 与 y1 的差值,
会由下面将提到的参数 depth 覆盖,即 depth 的取值会决定 y1 的大小,y1=y0+depth。
比如:设置成为 0 0 5.1 2 (之后的坐标定义与此完全不同,具体后面会提到)
◆ 右击 user_grid,选择
,点击前面的“+”符号,双击 “sprocess”
在对话框中点击
,在如下图所示的弹出框内,输入网格的设置与材料
的定义。
如下面的设置:
line x location=0 spacing=0.01 tag=Top
line x location=0.5 spacing=0.05
变量和宏工艺流程新建宏转换成语句还原参数显示、修改区类属列表工艺列表宏列表�
line x location=1 spacing=0.1
line x location=2 spacing=0.2 tag=Bottom
line y location=0 spacing=0.05 tag=Left
line y location=5.1 spacing=0.05 tag=Right
region silicon xlo=Top xhi=Bottom ylo=Left yhi=Right
location 标明位置,spacing 设置在该位置的网格间距,位于两个 location 之间的部分的
网格间距介于两端所设的 spacing 数值之间,一般以近似线性变化。Tag 设置了一些参数,
作为仿真区域 region 的边界。
如该例子中的设置:在纵向,即 x 方向,垂直晶圆方向,坐标为 x=0 处附近的沿着 x
方向的网格间距为 0.01um,并把该线,即 x=0 定义为一个参数,叫做 Top;在 x=0.5 处附近
沿着 x 方向的网格间距为 0.05um,那么在 x=0 至 x=0.5 之间的区域,沿着 x 方向的网格间距
会由 0.01um 逐渐变化到 0.05um。y 方向的含义以此类推。
Region 语句定义材料的边界。如上例,定义了硅材料,它的边界分为上下左右,分别
用 xlo,xhi,ylo,yhi 表示(x 坐标 low,靠上;high 则靠下)。
◆ 其它的设置保持默认值。
Substrate 衬底参数设置:
◆ Dopant 设置杂质类型,如为 P 型掺杂,选择 boron
◆ Concentration 浓度设置,如 1e15,表示浓度为 1*1015/cm3
另:关于类属功能。实际仿真中,在保证原有工艺流程的前提下,还可以进行一些配置,如
上图右边所示。其中加载和保存结构属于软件的“类属功能模块”,该功能模块含有下
面的几项:
注释
与注释类似,仅在翻译成命令行格式时文字外围的花纹不同
工艺流程中插入的命令行操作
加载已存为 dump 格式的工艺结构
保存当前实现的工艺结构
关于宏,Macro。宏是用户定义的一个打包的工艺流程,其内部含有某些工艺操作的组
合。用到宏一般有两种原因:一是为了整个工艺流程的条例清晰,将实现某些特定功能
的工艺步骤打包,并命名为有一定意义的宏名,便于之后检查和修改;二是某些工艺步
骤的组合出现次数较多,将其打包,会使得调用方便,也同样会使流程简洁清晰。
创建一个新的宏。点选
,点击工具栏中 图标,会返回一个新的
宏,并提示输入宏名称。在光标后输入宏名后,注意要按回车键,否则宏不能被保存。
宏名称不要使用软件中已有的关键词,如“main,epitaxy”等,也不要使用“!·#¥”
等类似字符。如,建立一个名为“epi”的宏。得到下图所示:
�
,
点击宏名前面的“+”符号,使其变为“-”符号,在工艺列表区用鼠标选择
并将其拖拽到宏名栏之上,待出现如下图所示的边框时松开鼠标,则外延工艺步骤已被
添加至宏“epi”中。
点击宏下的
值。双击某项,就可以对其进行修改。
图标,在变量显示与修改区会出现与外延工艺相关的变量及取
如上图双击“time”,将时间修改为 2,单位 hour,Ok。其它参数也都如此方法修改。其中
side 和 type 项使用默认项,无需修改。这样就完成了一个宏的完整定义。对于含有多项工
艺步骤的宏,只要按照顺序将相应的工艺步骤拖拽至相应位置,并修改工艺参数即可。
4. 按照之后列表中的工艺流程,添加入工艺流程显示区。
◆ 按住鼠标左键,将所需要的工艺步骤从工艺列表中拖出,拖到工艺流程显示区,然
后修改变量显示区与修改区的参数值,便完成了一步工艺设置。
◆ 关于工艺操作。涉及到的工艺操作如下:
使用掩模板光刻
直接用坐标定义掩模范围
外延
淀积
腐蚀
杂质注入
退火
准备就绪,下面开始工艺流程:
首先是初始定义的衬底图示(environment),注意坐标,之后参数修改的坐标都以此为标准
�
工艺流程:
步
骤
功能概括、
工艺步骤
1
EPI
insert
2
epitaxy
参数
双击 sprocess
打开 Open Text Area
输入
mgoals min.normal.size=5
max.lateral.size=0.1
normal.growth.ratio=1.2
Time 2 hour
Temperature 1100 ℃
Thick 4 μm
Dopant boron
Concentration 1e15/cm3
备注
外延生长
之后每结束一个蓝色标题,都会
给出此时的一个结构图
min.normal.size=5
max.lateral.size=0.1
normal.growth.ratio=1.2 语 句 一
定要接在 mgoals 之后,可用空
格格开,但是不可换行
mgoals 语句具体意义见表后
左栏为工艺参数,下面对参数的
给出将不再使用这种形式,会省
略参数名称,只给出参数值,由
于数值与单位成对出现,不会造
成歧义。参数表中未涉及的部分
使用默认设置,不需改动。
3
4
5
TRENCH
deposit
Oxide
11 nm
deposit
pattern2d
Deposition_type isotropic
(淀积类型为各项同性)
nitride(即 SiN)
165 nm
isotropic
双击 segments,修改 Value array
size 至 4,单击 OK
点击 segment 前+号,分别修改
[„]0 至[„]3 参数,例如分别设
为:-0.1 0.5 0.7 5.5 单位都是
um
Thick 1 μm
浅槽隔离
坐标两两一组。分别在
-0.1 至 0.5μm
0.7 至 5μm
两区域内有掩模存在
若 array size 为 2,则这两个数
之间,就是掩膜存在之处
�
6
etch
nitride
165 nm
Etch_type anisotropic
Overetch 10
7
8
9
etch
etch
Oxide
11 nm
Etch_type anisotropic
Overetch 10
Silicon
0.45 um
anisotropic
etch
Resisit
Etch_type strip
10
deposit
Oxide
11 nm
isotropic
11
deposit
Oxide
0.62 um
isotropic
12
13
14
15
pattern2d
segments 0.5 um 0.7 um
etch
etch
thickness 3um
Oxide
0.6 um
Overetch 20
resist
strip
etch
material Oxide
etch_type default
type from type definition
sprocess 打开 Open Text Area
输入:
type=cmp coord=-4.03
Etch_type anistropic 刻 蚀 类
型 各向异性,即只有纵向刻蚀,
没有横向 刻蚀效 果。Overetch
为:在达到刻蚀深度之后,再进
一步进行刻蚀的幅度,以百分比
计算,设置 10,表明要在设定
基础上,再多刻蚀 10%
采用 strip 剥离法去除光刻胶掩
模,因为是全部剥离,故刻蚀厚
度不需设置,即使设置也会因
strip 而被覆盖。
各向同性生长一薄层
16
etch
material Nitride
etch_type default
type from type definition
sprocess 打开 Open Text Area
输入:
type=cmp coord=-4.03
和 15 实际是一步,但是这里只
能一次定义一种材料,所以分开
写
17
etch
Nitride
�
18
etch
19
deposit
strip
oxide
11 nm
anisotropic
Oxide
11 nm
isotropic
20
21
implant
22
implant
PW
P 阱注入
pattern2d
segments 0.9 um 3.3 um
thickness 3 um
species boron
dose 1.5e13 /cm2
energy 180 keV
tilt 0 deg
rotation 0 deg
indium
7e12
170 keV
tilt 0 deg
rotation 0 deg
掺杂杂质 boron
剂量
能量
两个注入角度看表后说明
�
CPI_1
pattern2d
segments 3 um 5.5 um
implant
thickness 3 um
bf2
2.5e12 /cm2
35keV
tilt 7 deg
rotation -90 deg
resist
strip
25
etch
23
24
26
27
VTNH
pattern2d
-0.1um2.8um 3.7um5.5um
thickness 3 um
implant
boron
2.5e12
5 keV
tilt 0 deg
resist
strip
28
etch
WELL ANNEAL
29
anneal
time 10 sec
temperature 1000 degC
tilt 若等于 0,那么 rotation 的数
值就不用考虑了,参考 tilt 与
rotation 定义
�
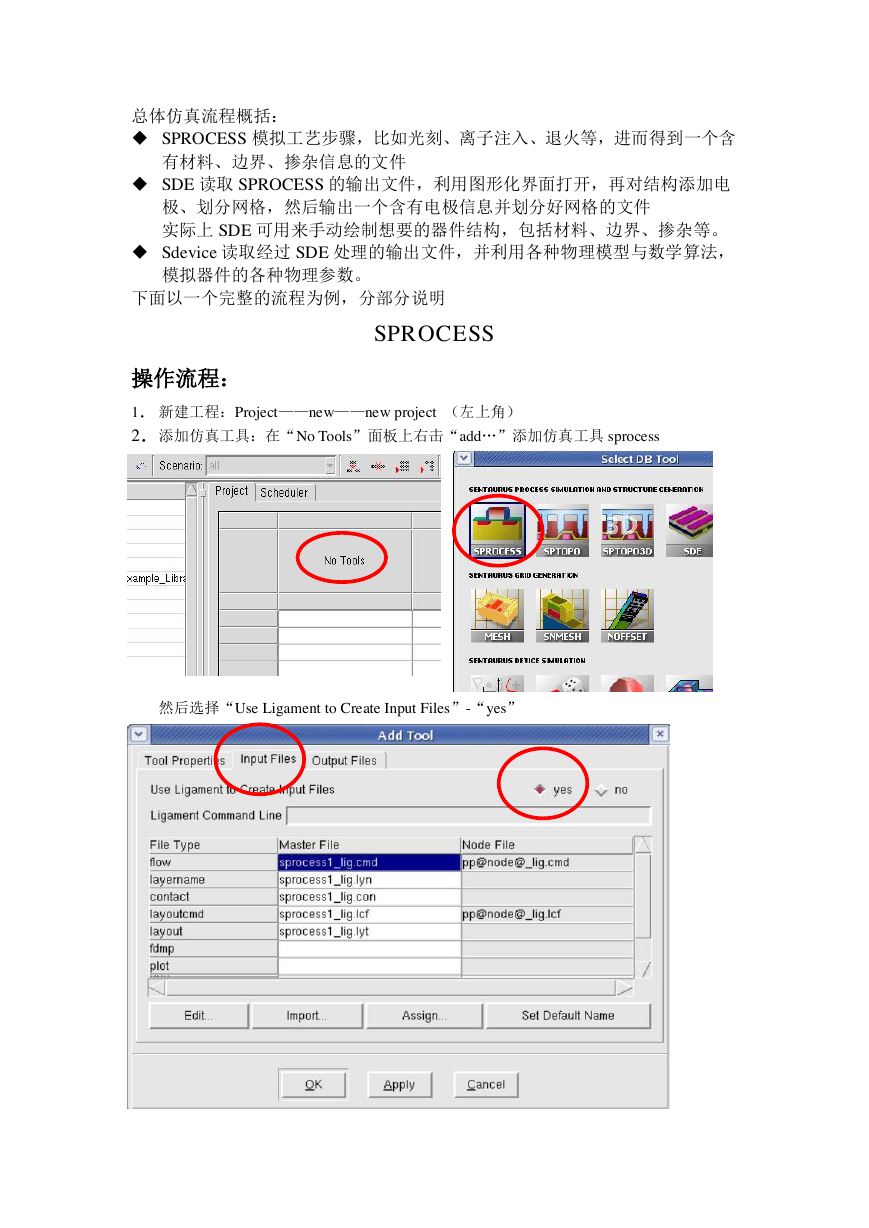
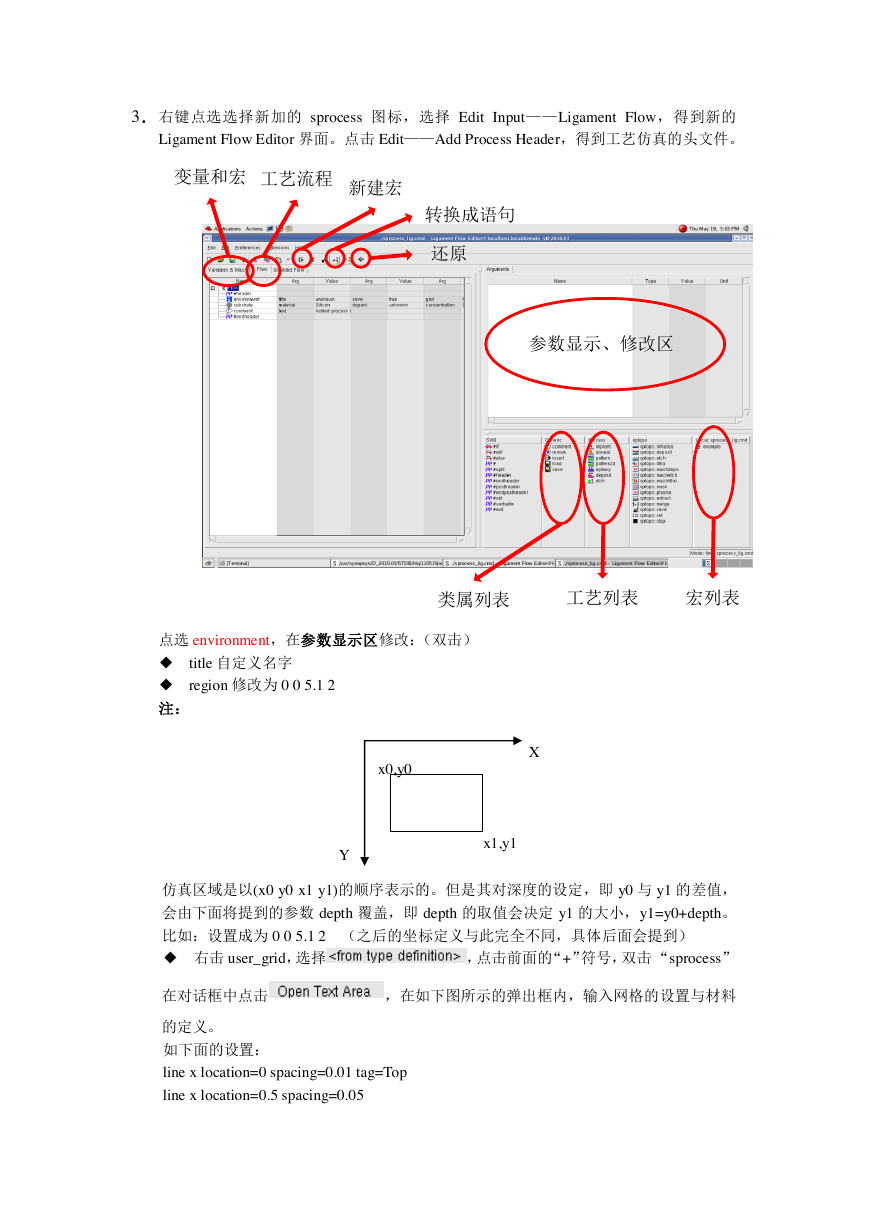




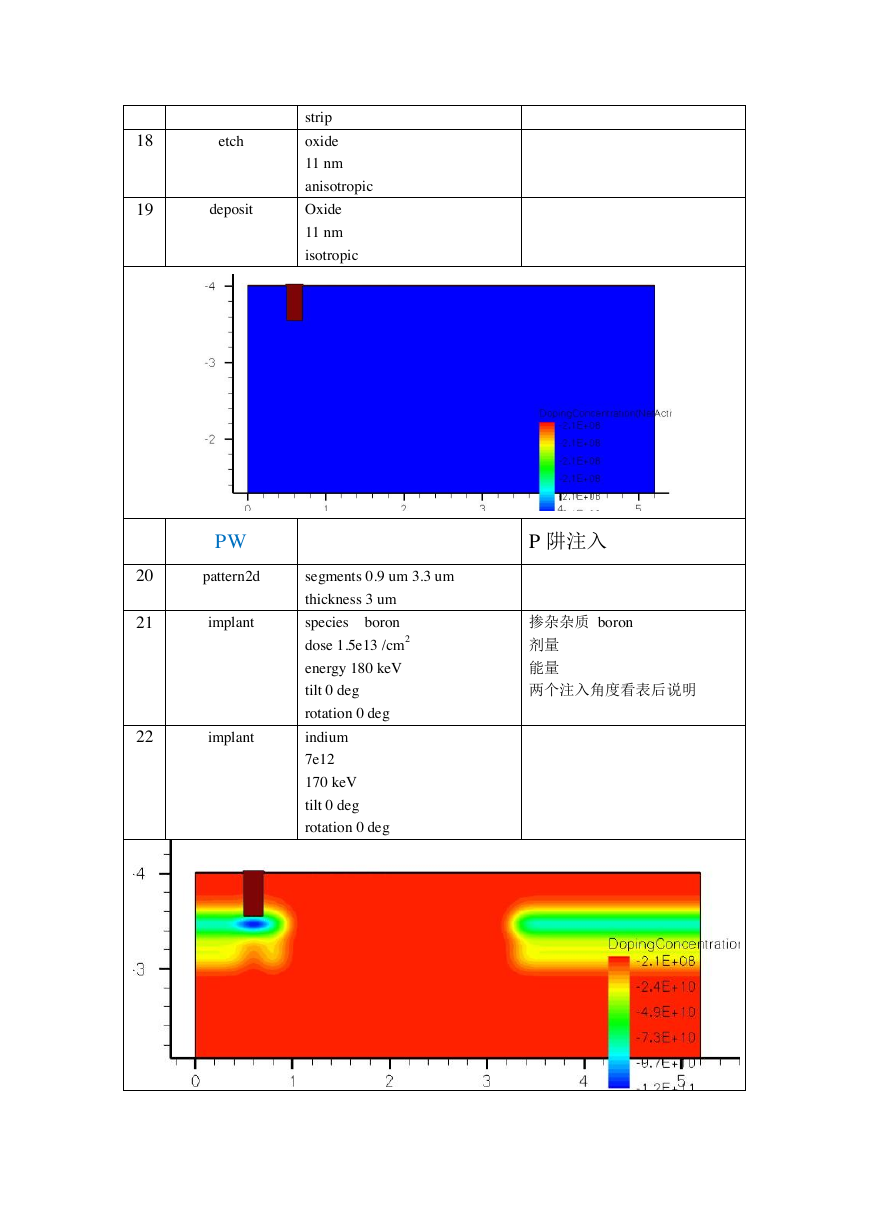
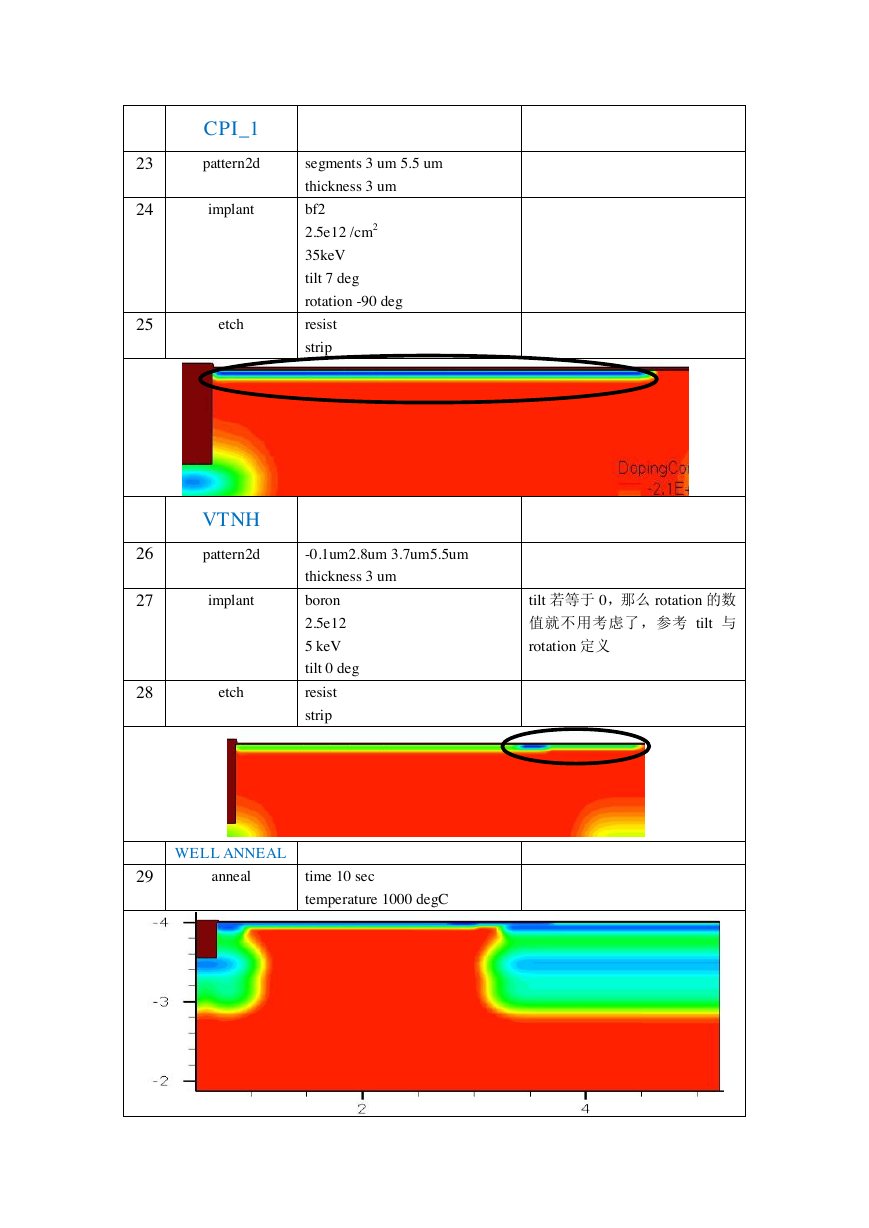
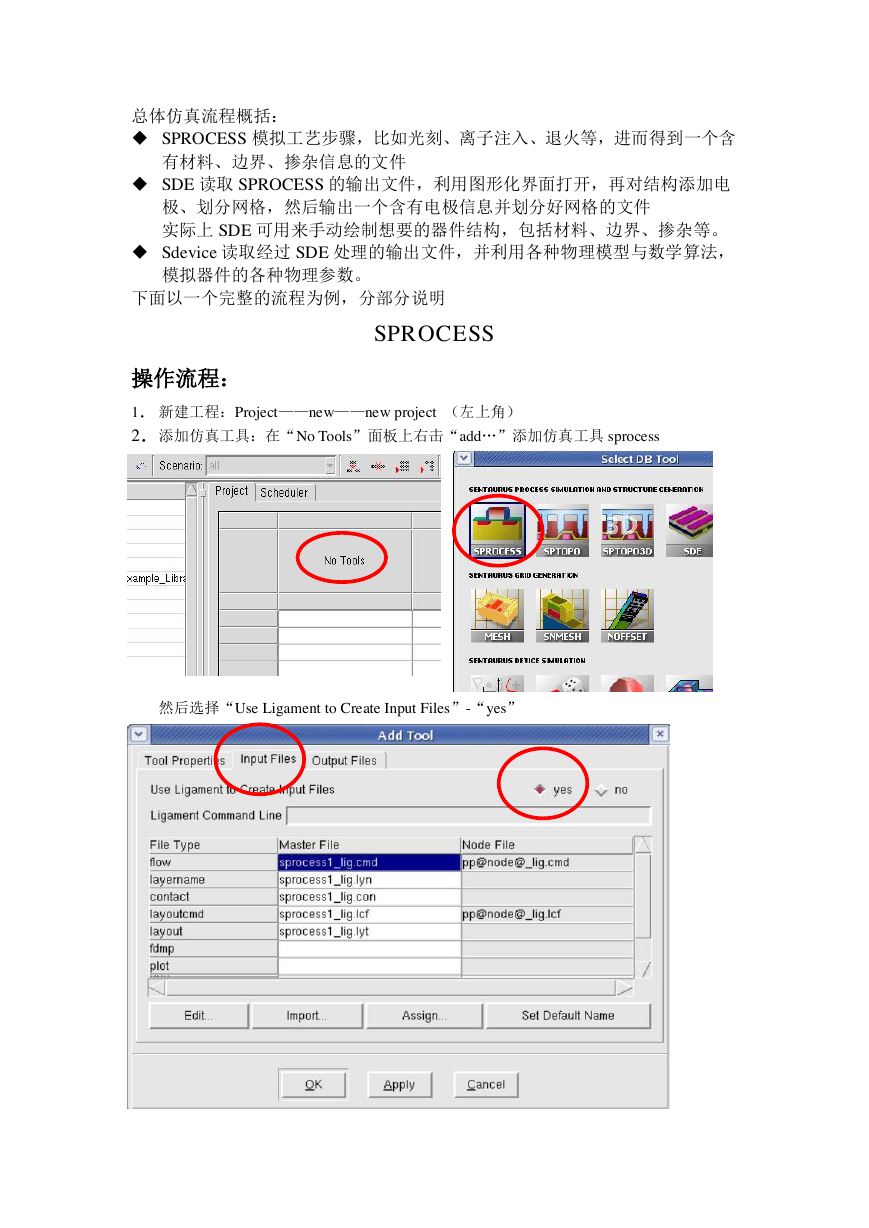
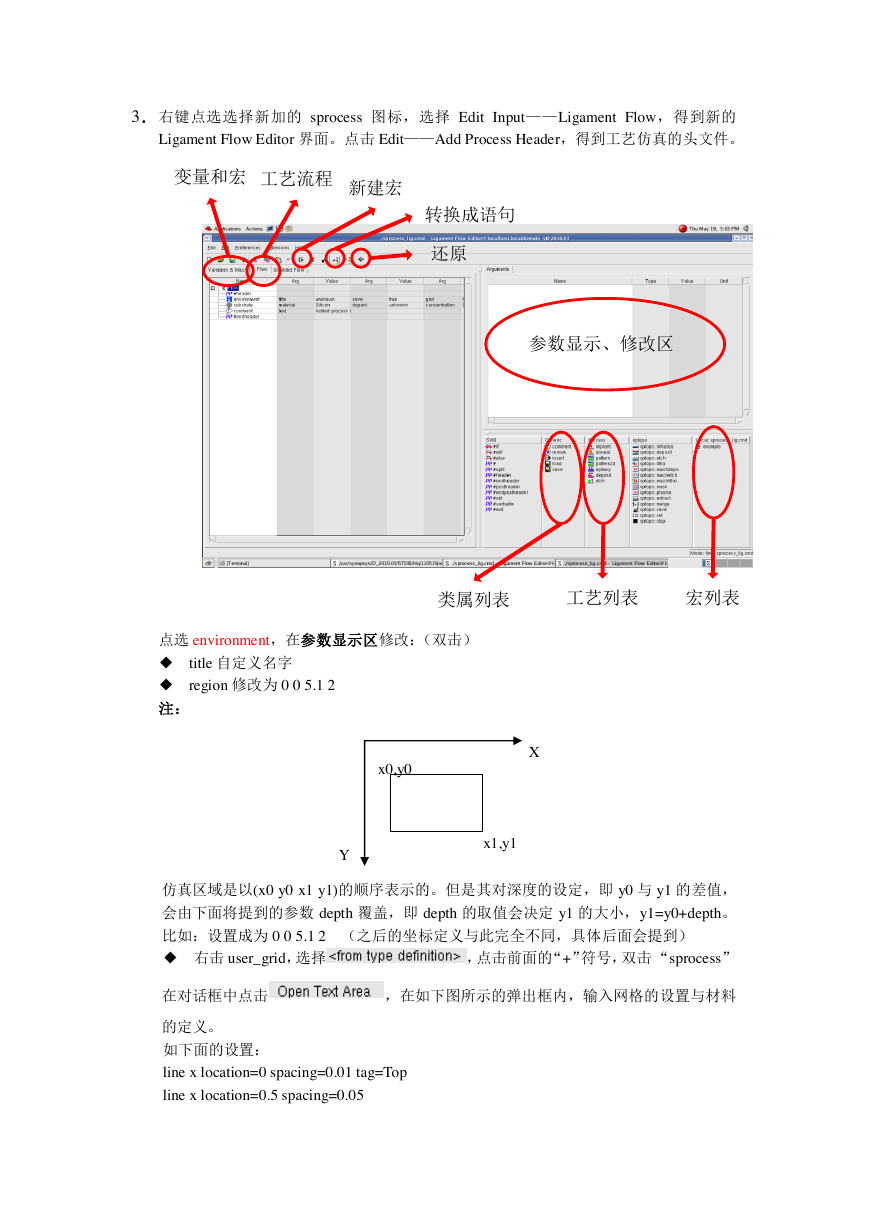




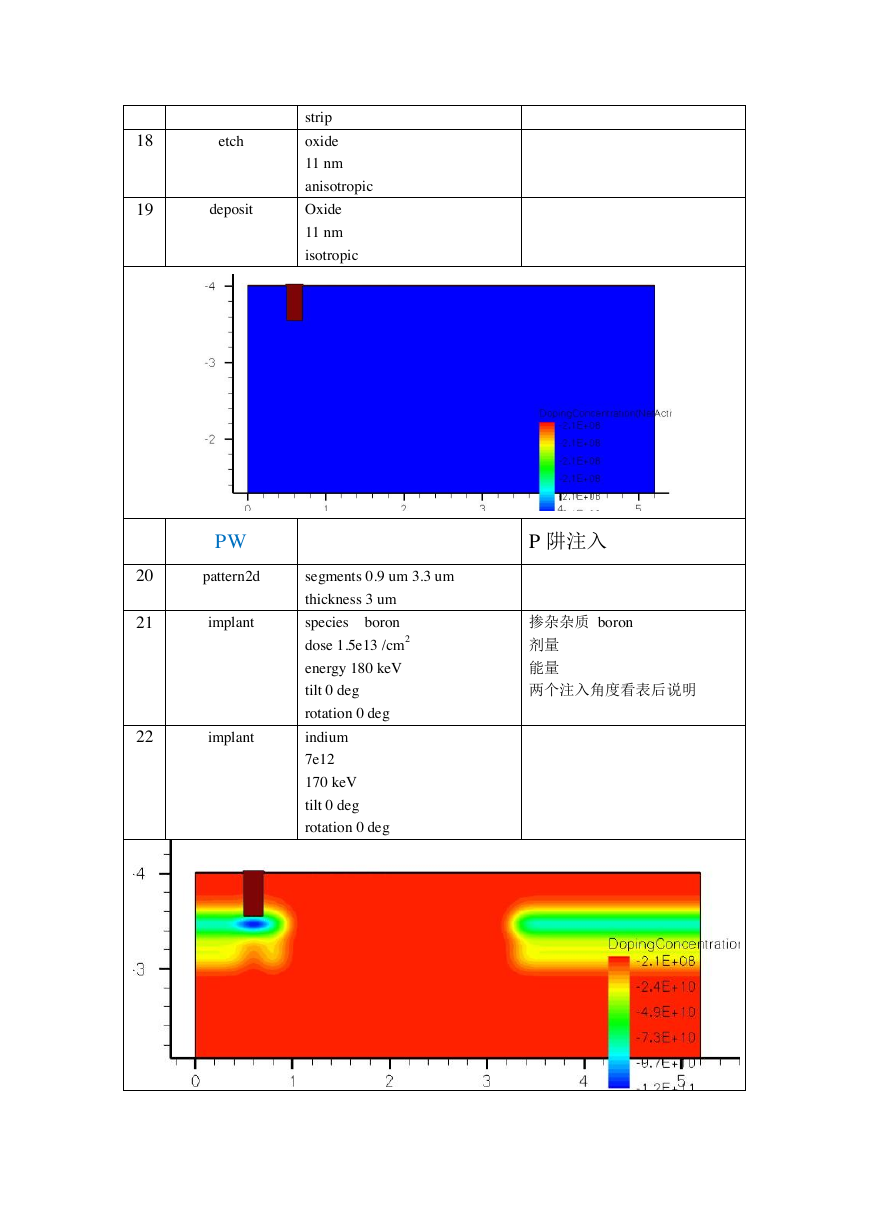
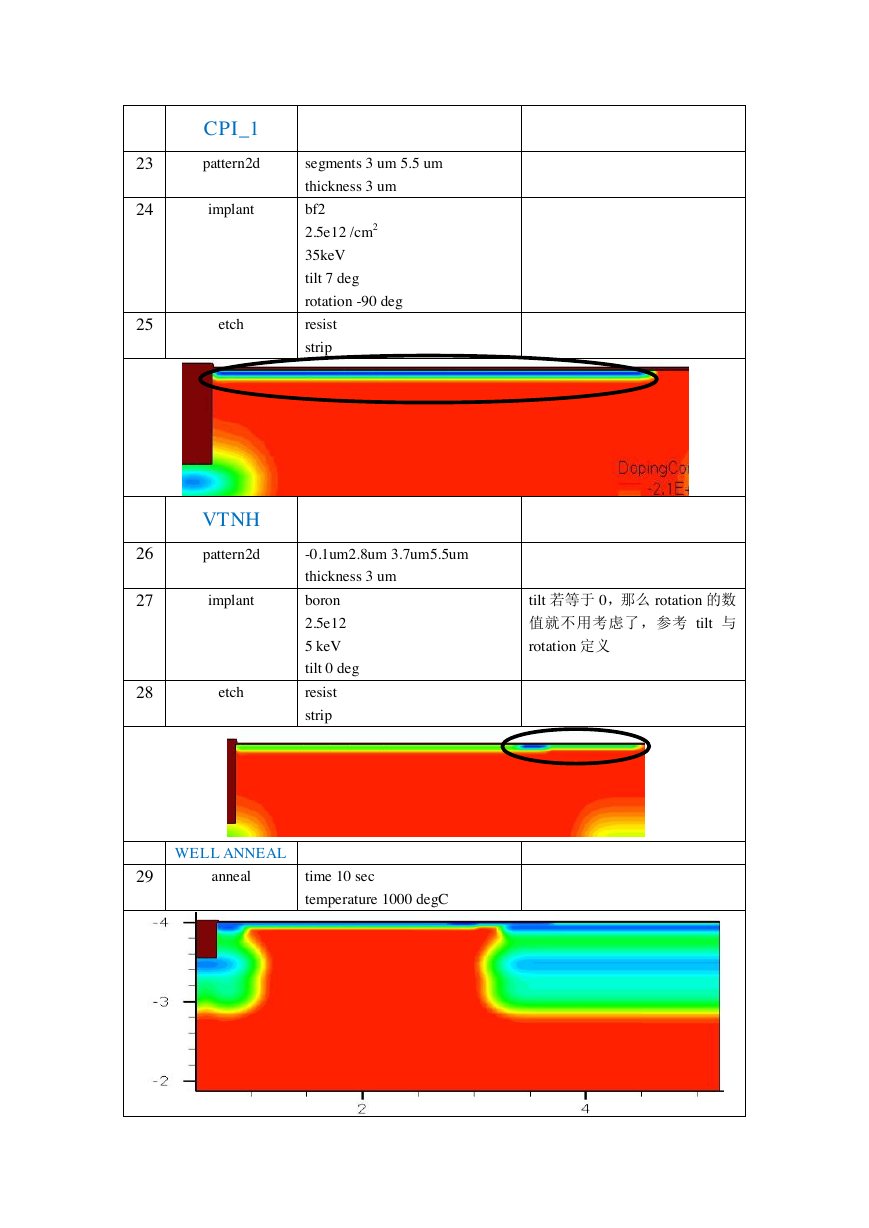
 2023年江西萍乡中考道德与法治真题及答案.doc
2023年江西萍乡中考道德与法治真题及答案.doc 2012年重庆南川中考生物真题及答案.doc
2012年重庆南川中考生物真题及答案.doc 2013年江西师范大学地理学综合及文艺理论基础考研真题.doc
2013年江西师范大学地理学综合及文艺理论基础考研真题.doc 2020年四川甘孜小升初语文真题及答案I卷.doc
2020年四川甘孜小升初语文真题及答案I卷.doc 2020年注册岩土工程师专业基础考试真题及答案.doc
2020年注册岩土工程师专业基础考试真题及答案.doc 2023-2024学年福建省厦门市九年级上学期数学月考试题及答案.doc
2023-2024学年福建省厦门市九年级上学期数学月考试题及答案.doc 2021-2022学年辽宁省沈阳市大东区九年级上学期语文期末试题及答案.doc
2021-2022学年辽宁省沈阳市大东区九年级上学期语文期末试题及答案.doc 2022-2023学年北京东城区初三第一学期物理期末试卷及答案.doc
2022-2023学年北京东城区初三第一学期物理期末试卷及答案.doc 2018上半年江西教师资格初中地理学科知识与教学能力真题及答案.doc
2018上半年江西教师资格初中地理学科知识与教学能力真题及答案.doc 2012年河北国家公务员申论考试真题及答案-省级.doc
2012年河北国家公务员申论考试真题及答案-省级.doc 2020-2021学年江苏省扬州市江都区邵樊片九年级上学期数学第一次质量检测试题及答案.doc
2020-2021学年江苏省扬州市江都区邵樊片九年级上学期数学第一次质量检测试题及答案.doc 2022下半年黑龙江教师资格证中学综合素质真题及答案.doc
2022下半年黑龙江教师资格证中学综合素质真题及答案.doc